Submitted:
02 March 2026
Posted:
03 March 2026
You are already at the latest version
Abstract
Keywords:
1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. Strutural Analysis

3.2. Thermal Properties
3.3. Rheological Properties
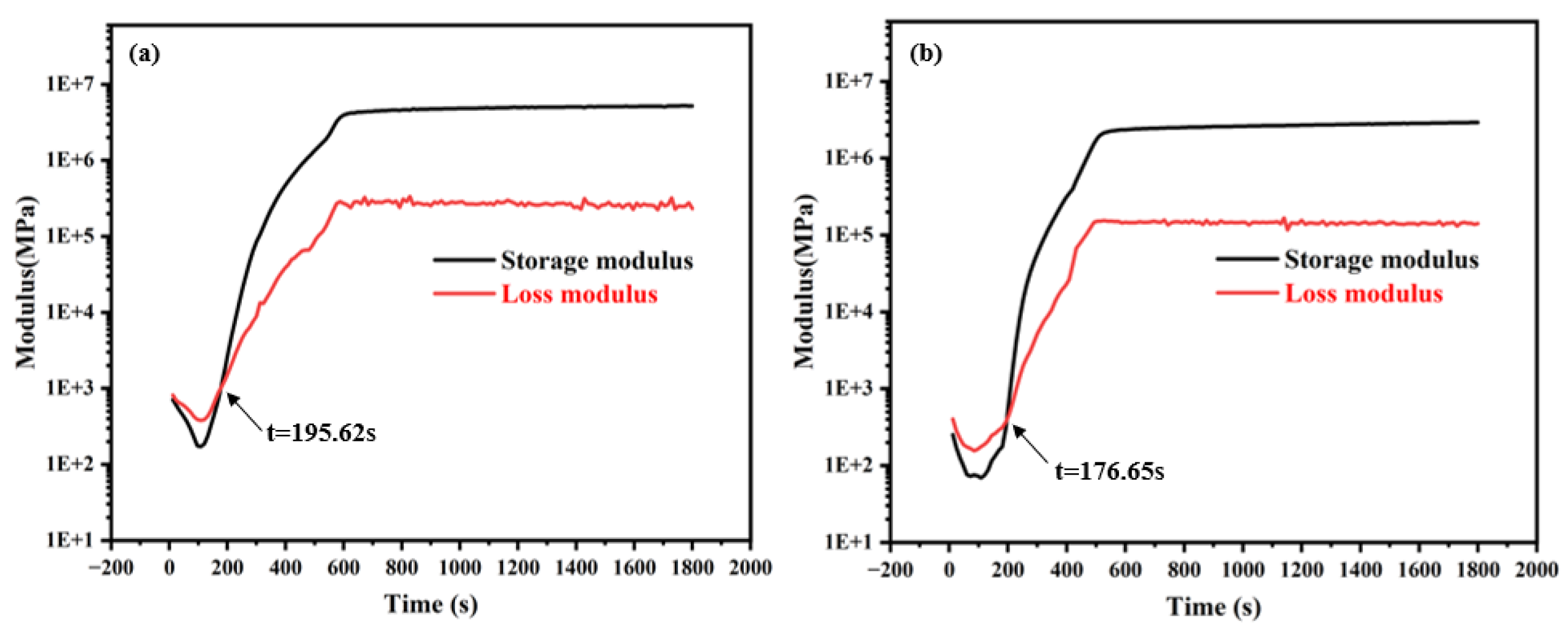
3.4. Thermal Conductivity
3.5. The Reliability Evaluation of Thermal Conductive Silicone Adhesive
3.5.1. Reliability of Thermal Conductivity
3.5.2. Reliability of Mechanical Property
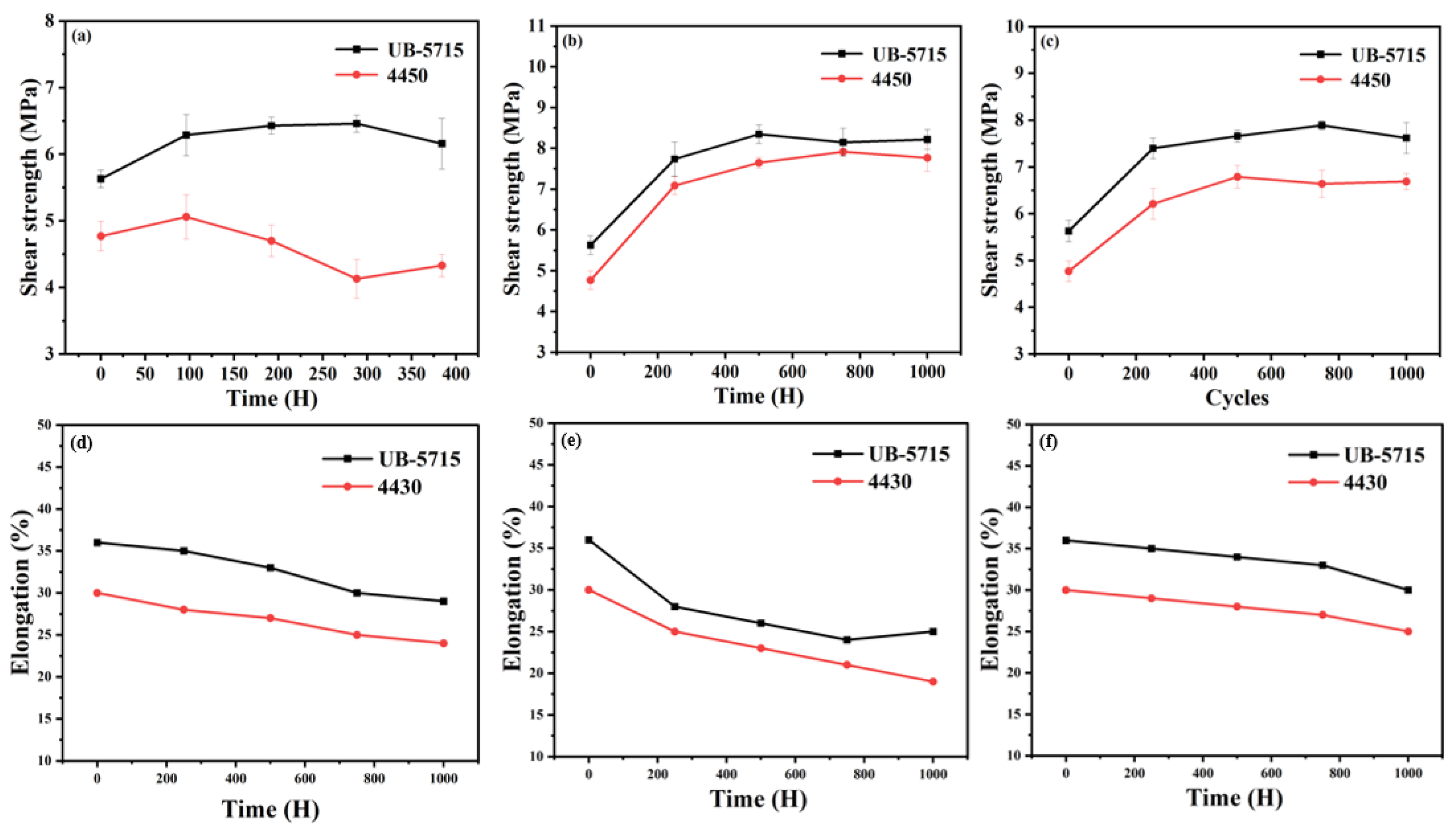
3.5.3. Analysis of Morphology After Aging
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Abdullah, M.F.; Lee, H.W. Technology Review of CNTs TSV in 3D IC and 2.5D Packaging: Progress and Challenges from an Electrical Viewpoint. Microelectronic Engineering 2024, 290, 112189. [Google Scholar] [CrossRef]
- Liang, C.-W.; Sung, Y.-C.; Hwang, S.-J.; Shih, M.-H.; Liao, W.-H.; Lin, T.-H.; Yang, D.-Y. Fan-out Panel-Level Package Warpage and Reliability Analyses Considering the Fabrication Process. Journal of Manufacturing Processes 2024, 119, 649–665. [Google Scholar] [CrossRef]
- Feng, C.-Y.; Zhang, P.; Wang, D.-W.; Zhao, W.-S.; Wang, J.; Christodoulides, P. Hybrid Neural Network Based Multi-Objective Optimal Design of Hybrid Pin-Fin Microchannel Heatsink for Integrated Microsystems. International Communications in Heat and Mass Transfer 2024, 159, 108137. [Google Scholar] [CrossRef]
- Yao, Y.; An, Y.; Dong, J.; Wang, Y.; Tu, K.N.; Liu, Y. Effect of Joule Heating on the Reliability of Microbumps in 3D IC. Journal of Materials Research and Technology 2024, 31, 3374–3382. [Google Scholar] [CrossRef]
- Xue, L.; Li, X.; Zhang, H. Thermal Stress and Drop Stress Analysis Based on 3D Package Reliability Study. Microelectronics Reliability 2023, 141, 114888. [Google Scholar] [CrossRef]
- Shih, M.-K.; Shih, S.; Liao, T.-W.; Chen, D.-L.; Liu, D.S.; Tarng, D. Investigation into Thermo-Mechanical Reliability of Copper Trace Lines in Stacked Dies Ball Grid Array Packaging. Microelectronics Reliability 2022, 130, 114488. [Google Scholar] [CrossRef]
- Li, Z.; Tan, J.; Li, J.; et al. A review on thermal management of light- emitting diodes:From package-level to system-level. Applied Thermal Engineering 2024, 257, 124145. [Google Scholar] [CrossRef]
- Kafil M. Razeeb.; Eric Dalton.; Graham Lawerence William Cross.; Anthony James Robinson. International Materials Reviews 2018, 1(18), 1–21. [CrossRef]
- Wu, Y.; Zhang, C.; Tu, W.; Du, G.; Zeng, X.; Sun, R.; Xu, Y.; Ren, L. Compliant Thermal Interface Materials via Introducing Pendent Chains into Polymer Networks for Chip Cooling. Composites Communications 2023, 37, 101452. [Google Scholar] [CrossRef]
- qi, Si; Fang, Cui; Na, Jiang; Liyi, Song; Ding, Shi Peng. Flexible Films for Smart Thermal Management: Influence of Structure Construction of a Two-Dimensional Graphene Network on Active Heat Dissipation Response Behavior. ACS Appl. Mater. Interfaces 2019, 11(33), 30352–30359. [Google Scholar] [CrossRef] [PubMed]
- Wang, W.; Zhou, W.; Shi, H. e al.Soft and thermally conductive gels by introducing free-movable polymer chains into network Polymer. 2023, 267, 125642. [Google Scholar] [CrossRef]
- Tan, J.; Zhu, G.; Yang, F.; Zhang, S.; Wu, Q.; Xu, L.; Li, Y.; Tan, L.; Meng, X.; Yu, J.; et al. Multi-Scale-Filler Reinforcement Strategy Enabled Stretchable Silicone Elastomer with Synergistically Enhanced Thermal Conductivity and Mechanical Strength. Composites Part A: Applied Science and Manufacturing 2023, 175, 107784. [Google Scholar] [CrossRef]
- Lin, Z.; Jin, H.; Deng, H.; Zu, Z.; Huang, H.; Zhang, L.; Xiang, H. Robust, Self-Healable, Recyclable and Thermally Conductive Silicone Composite as Intelligent Thermal Interface Material. Composite Structures 2024, 332, 117932. [Google Scholar] [CrossRef]
- Deng, M.; Xu, Y.; Gao, K.; et al. A graphene nanoflake-based flexible composite phase change material for enhanced heat dissipation in chip cooling. Applied Thermal Engineering 2024, 245, 122908. [Google Scholar] [CrossRef]
- Li, Z.; Sun, Y.; Hu, F.; et al. An overview of polymer-based thermally conductive functional. Journal of Materials Science & Technology 2024, 218, 191–210. [Google Scholar] [CrossRef]
- Liu, J.; Fang, Z.; An, J.; Bao, C. Effect of the Cross-Linking of Polyorganosiloxane on Highly Thermally Conductive Silicone Rubber’s Mechanical, Dielectric, and Thermally Conductive Properties and Thermal Reliability. Composites Communications 2024, 45, 101781. [Google Scholar] [CrossRef]
- Jinkins, K.R.; Li, S.; Arafa, H.; Jeong, H.; Lee, Y.J.; Wu, C.; Campisi, E.; Ni, X.; Cho, D.; Huang, Y.; et al. Thermally Switchable, Crystallizable Oil and Silicone Composite Adhesives for Skin-Interfaced Wearable Devices. Sci. Adv. 2022, 8. [Google Scholar] [CrossRef]
- Tian, XU. Thermal Management Materials for Electronic Packaging: Preparation, Characterization, and Devices. John Wiley & Sons, 2023; pp. 290–291. [Google Scholar]
- Liu, H.; Hu, J.; Yang, W.; et al. Honeycomb networks of boron nitride/nanodiamond with interlocking interfaces enhance the application reliability of silicone rubber thermal conductivity composites. Polymer Composites 2024, 45(10), 9064–9078. [Google Scholar] [CrossRef]
- Hu, X.; Wei, S.; Zhang, Y.; Lin, Q.; Chen, X.; Cai, L.; Dong, H.; Song, Y.; Qu, Z.; Wu, C. Preparation of Thermal Interface Materials with High Thermal Conductivity through the Synergistic Effect of Monoalkoxy-Terminated Polysiloxane and Branched Siloxane Oligomers. European Polymer Journal 2024, 211, 113042. [Google Scholar] [CrossRef]
- Ye, B.; Li, L.; Dai, K.; et al. Facile preparation of thermally conductive fiber film by self-assembling interconnected boron nitride nanosheets for effective thermal interface materials. Polymer Composites 2024, 45(9), 8426–8435. [Google Scholar] [CrossRef]
- Yongdong, Wu; Chenxu, Zhang; Wendian, Tu; Guoping, Du; Xiaoliang, Zeng; Rong, Sun; Yonglun, Xu; Linlin, Ren. Compliant thermal interface materials via introducing pendent chains into polymer networks for chip cooling. Composites Communications 2023, 37, 101452. [Google Scholar]
- Liu, W.; Liu, Y.; Zhong, S.; et al. Soft and Damping Thermal Interface Materials with Honeycomb-Board-Mimetic Filler Network for Electronic Heat Dissipation Small. 2024, 20(35), 2400115. [Google Scholar]
- Yu, Y.; Wang, M.; Foix, D.; Li, S. Rheological Study of Epoxy Systems Blended with Poly(Ether Sulfone) of Different Molecular Weights. Ind. Eng. Chem. Res. 2008, 47, 9361–9369. [Google Scholar] [CrossRef]
- Bagetti Jeronimo, M.; Schindele, J.; Straub, H.; Gromala, P.J.; Wunderle, B.; Zimmermann, A. On the Influence of Lid Materials for Flip-Chip Ball Grid Array Package Applications. Microelectronics Reliability 2023, 140, 114869. [Google Scholar] [CrossRef]
- Huang, T.; Zhang, X.; Wang, T.; et al. Self-Modifying Nanointerface Driving Ultrahigh Bidirectional Thermal Conductivity Boron Nitride-Based Composite Flexible Films. Nano-Micro Letters 2023, 15(1), 2. [Google Scholar] [CrossRef]
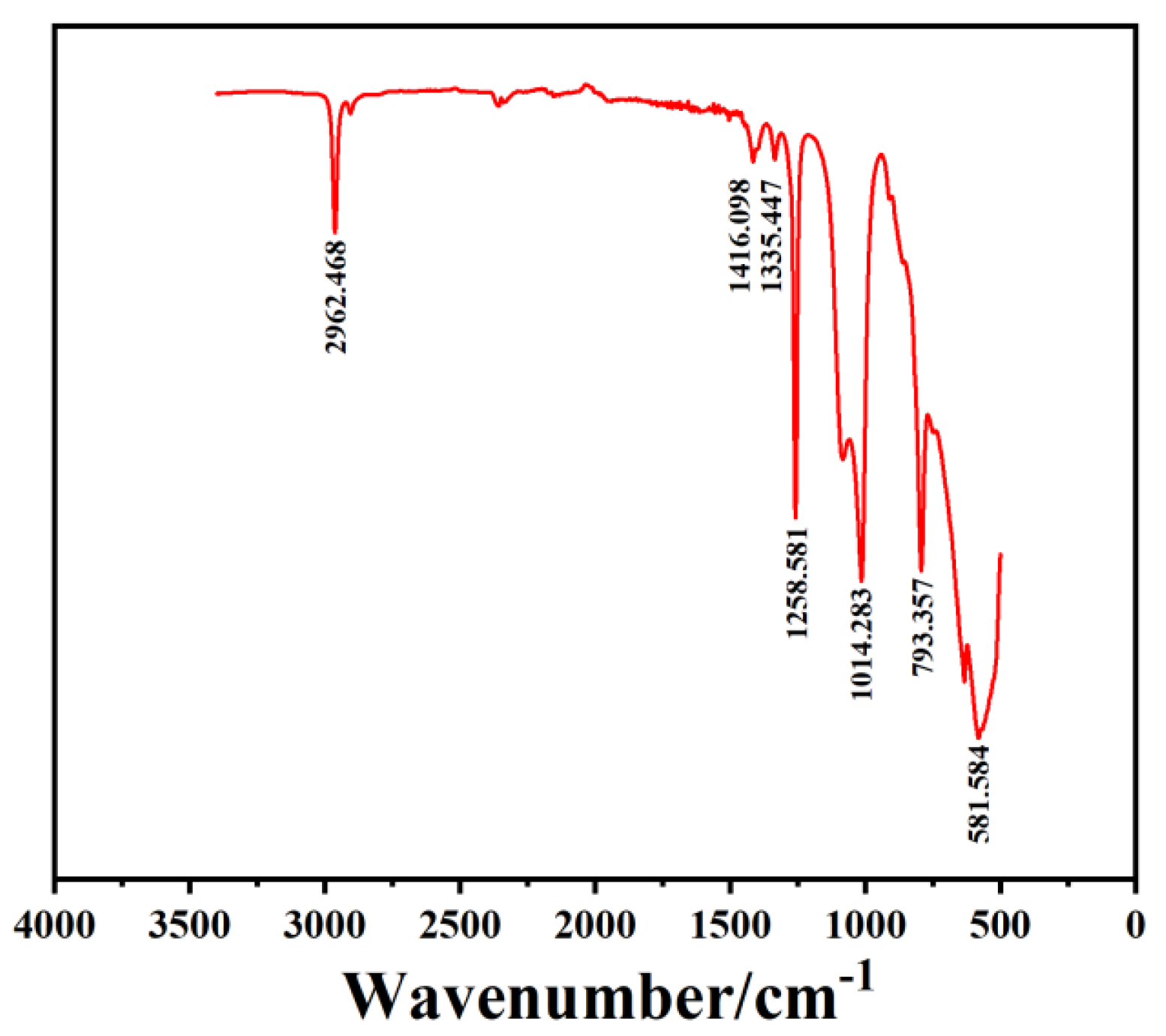




| Sample |
Thermal Conductivity W·m-1·K-1 |
Thermal Resistance ℃·cm2·W-1 |
| UB-5715 | 1.80 | 10.947 |
| 4450 | 1.70 | 11.134 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2026 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).




