Submitted:
29 August 2025
Posted:
01 September 2025
You are already at the latest version
Abstract
Keywords:
Introduction
- Mass transport, including the role of percolated networks in facilitating the diffusion of stable molecules, plasma radicals, and environmental contaminants;
- Mechanical properties, with an emphasis on how pore connectivity impacts elastic modulus, hardness, toughness, and reliability under mechanical stress;
- Electrical characteristics, particularly how percolation alters dielectric breakdown strength, leakage currents, and long-term reliability.
- The structure of this review is as follows:
- Chapter 1 examines mass transport mechanisms in porous low-k films, with a focus on how percolation controls diffusivity and reactive species infiltration.
- Chapter 2 explores how percolation affects key electrical properties, including permittivity, breakdown voltage, and dielectric degradation.
- Chapter 3 discusses the mechanical consequences of percolation, including stress localization, fracture pathways, and mechanical failure modes.
- The conclusion highlights the broader implications of percolation for material design and outlines strategies for mitigating percolation-driven degradation while achieving ultra-low-k performance.
1. Mass Transport and the Role of Percolated Networks in Facilitating the Diffusion of Stable Molecules, Plasma Radicals, Positronium (Ps) and Environmental Contaminants
1.1. Fabrication of Porous Low-k Films
1.2. Types of Porosity and Mass Transport
- p < pс → no continuous path exists → macroscopic transport is effectively zero.
- p > pс → a connected network exists → transport becomes possible.
1.3. Depth Profile of Plasma-Induced Damage
1.3.1. Damage by Active Radicals
1.3.2. Damage by Ion Bombardment
- Top Power Only (TPO) – generating plasma radicals without ion bombardment;
- Bottom Power Only (BPO) – applying a bias to the bottom electrode, resulting in strong ion bombardment with minimal radical generation;
- Top and Bottom Power (T&BP) – combining both plasma radicals and ion bombardment.
1.3.3. VUV Damage
1.4. Conclusions
2. Percolation Phenomena Governing Electrical Failure in Low-k Films
2.1. General Overview of Percolation Phenomena in Porous OSG Low-k Films
2.1.1. Dielectric Constant and Leakage Current vs. Porosity and Chemical Composition
- 1.
- 350 °C – 450 °C.
- 2.
- 450 °C – 700 °C.
- 3.
- 700 °C – 900 °C
2.1.2. Leakage Current in Porous Low-k Films and Reliability
2.1.3. Breakdown Voltage
- Integration control: Pore stuffing (P4 approach) with pore protection by deposited polymers [79,80] and cryogenic etching (− 100 °C), which condenses byproducts to minimize plasma damage [79], silylation passivates Si–OH traps, and stress-graded porosity design weakens field enhancement by 30–50% [76]. These approaches collectively shift the percolation threshold, suppress defect connectivity, and restore dielectric robustness even at ULK regimes.
3. Mechanical Properties of Porous Low-k Materials
3.1. Mechanical Properties Versus Connectivity and Porosity
3.1.1. Mechanical Properties Versus the Matrix Connectivity (dense OSG)
3.1.1. Mechanical Properties Versus Porosity (Porous OSG)
3.2. Stiffness Enhancement Strategies in Low-k and Hybrid Glasses
3.3. Non-Affine Deformations Control
4. Conclusions
- 1.
- Percolation Threshold for Leakage Current and mass transfer.
- 2.
- Percolation Threshold for Dielectric Breakdown
- local defect accumulation and hot-spot formation,
- field enhancement at pore edges,
- charge trapping, and
- progressive filament growth.
- 3.
- Mechanical Percolation
- 4.
- Experimental Trends
- Leakage current rises sharply at relatively low porosity.
- Breakdown voltage and mechanical modulus collapse abruptly at higher porosity, typically in the range of 20–30% (depending on pore size and connectivity), just above the percolation threshold for open pores.
- 5.
- Distinct Percolation Classes
- Transport phenomena: mass diffusion, electrical conduction, and leakage current.
- Mechanical phenomena: degradation of stiffness and strength.
- Nonlinear phenomena: dielectric breakdown.
- 6.
- Correlation Length and Timescales
- 7.
- Elastic and Breakdown Percolation
Supplementary Materials
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
Abbreviations
| ULSI | Ultra large scale integrated |
| RC | Resistance-Capacitance |
| CTE | Coefficient of thermal expansion |
| NTRS | National Technology Roadmap for Semiconductors |
| ITRS | International Technology Roadmap for Semiconductors |
| PECVD | Plasma-enhanced chemical vapor deposition |
| ULK | Ultralow-k |
| OSG | Organosilicate glass |
| IRDS | International Roadmap of Devices and Systems |
| CMP | Chemical mechanical polishing |
| PALS | Positron annihilation lifetime spectroscopy |
| EP | Ellipsometric porosimetry |
| VUV | Vacuum ultraviolet |
| TPO | Top power only |
| BPO | Bottom power only |
| T&BP | Top and bottom power |
| PF | Poole-Frenkel |
| TDDB | Time-dependent dielectric breakdown |
| ODC | Oxygen-deficient centers |
| FSG | Fluorinated silica |
| NRA-RBS | Nuclear reaction analysis- Rutherford backscattering |
| P-MSQ | Methylsilsequioxane |
| ALD | Atomic layer deposition |
| FTIR | Fourier-transform infrared spectroscopy |
| HS | Hashin-Shtrikman |
| NI | Nanoindentation |
References
- Edelstein, D.; Heidenreich, J.; Goldblatt, R.; Cote, W.; Uzoh, C.; Lustig, N.; Roper, P.; McDevitt, T.; Motsiff, W.; Simon, A.; et al. Full copper wiring in a sub-0. In 25 μm CMOS ULSI technology. In Proceedings of the International Electron Devices Meeting (IEDM), Washington, DC, USA, 7–10 December 1997; pp. 773–776. [Google Scholar] [CrossRef]
- Andricacos, P.C.; Uzoh, C.; Dukovic, J.O.; Horkans, J.; Deligianni, H. Damascene copper electroplating for chip interconnections. IBM J. Res. Dev. 1998, 42, 567–574. [Google Scholar] [CrossRef]
- Havemann, R.H.; Hutchby, J.A. High-performance interconnects: An integration overview. Proc. IEEE 2001, 89, 586–601. [Google Scholar] [CrossRef]
- Ravindra, N.M. International Technology Roadmap for Semiconductors (ITRS). J. Electron. Mater. 2001, 30, 1478–1627. [Google Scholar]
- Ryan, E.T.; McKerrow, A.J.; Leu, J.; Ho, P.S. Materials issues and characterization of low–k dielectric materials. MRS Bull. 1997, 22, 49–54. [Google Scholar] [CrossRef]
- Harper, C. Electronic Packaging and Interconnection Handbook, 4th ed.; McGraw-Hill: New York, NY, USA, 2004. [Google Scholar]
- Maex, K.; Baklanov, M.R.; Shamiryan, D.; Lacopi, F.; Brongersma, S.H.; Yanovitskaya, Z.S. Low dielectric constant materials for microelectronics. J. Appl. Phys. 2003, 93, 8793–8841. [Google Scholar] [CrossRef]
- International Roadmap for Devices and Systems (IRDS), 2024 Update: More Moore; IEEE: Piscataway, NJ, USA, 2024. Available online: https://irds.ieee.org/editions/2024.
- Y Nakata, Y.; Ozaki, S.; Kudo, H. Multilevel interconnect technology for 45-nm node CMOS LSIs. Fujitsu Sci. Tech. J. 2010, 46, 120–127. [Google Scholar]
- Baklanov, M.R.; de Marneffe, J.F.; Shamiryan, D.; Urbanowicz, A.M.; Shi, H.; Rakhimova, T.V.; Huang, H.; Ho, P.S. Plasma processing of low–k dielectrics. J. Appl. Phys. 2013, 113, 041101. [Google Scholar] [CrossRef]
- Soulié, J.P.; Sankaran, K.; Van Troeye, B.; Leśniewska, A.; Pedreira, O.V.; Oprins, H.; Delie, G.; Fleischmann, C.; Boakes, L.; Rolin, C.; et al. Selecting Alternative Metals for Advanced Interconnects, J. Appl. Phys. 2024, 136, 171101. [Google Scholar] [CrossRef]
- Dull, T.L.; Frieze, W.E.; Gidley, D.W.; Sun, J.N.; Yee, A.F. Determination of pore size in mesoporous thin films from the annihilation lifetime of positronium. J. Phys. Chem. B 2001, 105, 4657–4662. [Google Scholar] [CrossRef]
- Baklanov, B.M.; Mogilnikov, K.P.; Polovinkin, V.G.; Dultsev, F.N. Determination of pore size distribution in thin films by el-lipsometric porosimetry. J. Vac. Sci. Technol. 2000, 18, 1385–1391. [Google Scholar] [CrossRef]
- Foran, B.J.; Kastenmeier, B.; Bright, D.S. Determination of pore-size distributions in low-k dielectric films by transmission electron microscopy. AIP Conf. Proc. 2003, 683, 556–561. [Google Scholar] [CrossRef]
- Sekhar, V.N. Mechanical characterization of black diamond (low-k) structures for 3D integrated circuit and packaging applications. In Nanoindentation in Materials Science; IntechOpen: London, UK, 2012. [Google Scholar] [CrossRef]
- Hatton, B.D.; Landskron, K.; Hunks, W.J.; Bennett, M.R.; Shukaris, D.; Perovic, D.D.; Ozin, G.A. Materials chemistry for low–k materials. Mater. Today 2006, 9, 22–31. [Google Scholar] [CrossRef]
- Baklanov, M.; Ho, P.S.; Zschech, E. (Eds.) Advanced Interconnects for ULSI Technology; John Wiley & Sons: Hoboken, NJ, USA, 2012. [Google Scholar]
- Kresge, A.C.; Leonowicz, M.E.; Roth, W.J.; Vartuli, J.C.; Beck, J.S. Ordered mesoporous molecular sieves synthesized by a liquid-crystal template mechanism. Nature 1992, 359, 710–712. [Google Scholar] [CrossRef]
- Grill, A.; Perraud, L.; Patel, V.; Jahnes, C.; Cohen, S. Low dielectric constant SiCOH films as potential candidates for interconnect dielectrics. MRS Proc. 1999, 565, 107. [Google Scholar] [CrossRef]
- Grill, A. PECVD low and ultralow dielectric constant materials: From invention and research to products. J. Vac. Sci. Technol. B 2016, 34, 020801. [Google Scholar] [CrossRef]
- Iacopi, F.; Travaly, Y.; Eyckens, B.; Waldfried, C.; Abell, T.; Guyer, E.P.; Gage, D.M.; Dauskardt, R.H.; Sajavaara, T.; Houthoofd, K.; et al. Short-ranged structural rearrangement and enhancement of mechanical properties of organosilicate glasses induced by ultraviolet radiation. J. Appl. Phys. 2006, 99, 053511. [Google Scholar] [CrossRef]
- Baklanov, M.R.; Jousseaume, V.; Rakhimova, T.V.; Lopaev, D.V.; Mankelevich, Y.A.; Afanas’ev, V.V.; Shohet, J.L.; King, S.W.; Ryan, E.T. Impact of VUV photons on SiO2 and organosilicate low-k dielectrics: General behavior, practical applications, and atomic models. Appl. Phys. Rev. 2019, 6, 011301. [Google Scholar] [CrossRef]
- Chang, T.C.; Tsai, T.M.; Liu, P.T.; Chen, C.W.; Tseng, T.Y. Study on the effect of electron beam curing on low–k porous organosilicate glass (OSG) material. Thin Solid Films 2004, 469, 383–387. [Google Scholar] [CrossRef]
- Cho, S.M.; Papasouliotis, G.D.; Barnes, M. Method for porogen removal and mechanical strength enhancement of low-k carbon doped silicon oxide using low thermal budget microwave curing. U.S. Patent 7,892,985, 22 February 2011. [Google Scholar]
- Nguyen, P.T.; Fan, C.; Do, D.D.; Nicholson, D. On the cavitation-like pore blocking in ink-bottle pore: evolution of hysteresis loop with neck size. J. Phys. Chem. C 2013, 117, 5475–5484. [Google Scholar] [CrossRef]
- Baklanov, M.R.; Mogilnikov, K.P. Non-destructive characterisation of porous low-k dielectric films. Microelectron. Eng. 2002, 64, 335–349. [Google Scholar] [CrossRef]
- Yim, J.H.; Seon, J.B.; Jeong, H.D.; Pu, L.S.; Baklanov, M.R.; Gidley, D.W. Morphological control of nanoporous films by the use of functionalized cyclodextrins as porogens. Adv. Funct. Mater. 2004, 14, 277–282. [Google Scholar] [CrossRef]
- Kondoh, E.; Baklanov, M.R.; Lin, E.L.; Gidley, D.G.; Nakashima, A.N. Comparative study of pore size of low-dielectric-constant porous spin-on-glass films using different methods of nondestructive instrumentation. Jpn. J. Appl. Phys. 2001, 40, L323. [Google Scholar] [CrossRef]
- Rasadujjaman, M.; Wang, Y.; Zhang, L.; Naumov, S.; Attallah, A.G.; Liedke, M.O.; Koehler, N.; Redzheb, M.; Vishnevskiy, A.S.; Seregin, D.S.; et al. A detailed ellipsometric porosimetry and positron annihilation spectroscopy study of porous organosilicate-glass films with various ratios of methyl terminal and ethylene bridging groups. Microporous Mesoporous Mater. 2020, 306, 110434. [Google Scholar] [CrossRef]
- Shamiryan, D.; Baklanov, M.R.; Lyons, P.; Beckx, S.; Boullart, W.; Maex, K. Diffusion of solvents in thin porous films. Colloids Surf. A Physicochem. Eng. Asp. 2007, 300, 111–116. [Google Scholar] [CrossRef]
- Vanstreels, K.; Wu, C.; Gonzalez, M.; Schneider, D.; Gidley, D.; Verdonck, P.; Baklanov, M.R. Effect of pore structure of nanometer scale porous films on the measured elastic modulus. Langmuir 2013, 29, 12025–12035. [Google Scholar] [CrossRef]
- Ben-Avraham, D. Diffusion and Reactions in Fractals and Disordered Systems; Cambridge University Press: Cambridge, UK, 2000. [Google Scholar]
- Arkhincheev, V.E. Anomalous diffusion and charge relaxation on comb model: Exact solutions. Physica A: Statistical Mechanics and Its Applications 2000, 280, 304–314. [Google Scholar] [CrossRef]
- Mogilnikov, K.P.; Baklanov, M.R.; Shamiryan, D.; Petkov, M.P. A discussion of the practical importance of positron annihilation lifetime spectroscopy percolation threshold in evaluation of porous low-k dielectrics. Jpn. J. Appl. Phys. 2004, 43, 247–247. [Google Scholar] [CrossRef]
- Shamiryan, D.; Baklanov, M.R.; Vanhaelemeersch, S.; Maex, K. Comparative study of SiOCH low–k films with varied porosity interacting with etching and cleaning plasma. J. Vac. Sci. Technol. B 2002, 20, 1923–1928. [Google Scholar] [CrossRef]
- Kunnen, E.; Baklanov, M.R.; Franquet, A.; Shamiryan, D.; Rakhimova, T.V.; Urbanowicz, A.M.; Struyf, H.; Boullart, W. Effect of energetic ions on plasma damage of porous SiCOH low–k materials. J. Vac. Sci. Technol. B 2010, 28, 450–459. [Google Scholar] [CrossRef]
- Shi, H.; Huang, H.; Bao, J.; Liu, J.; Ho, P.S.; Zhou, Y.; Pender, J.T.; Armacost, M.D.; Kyser, D. Role of ions, photons, and radicals in inducing plasma damage to ultra low–k dielectrics. J. Vac. Sci. Technol. B 2012, 30, 011206. [Google Scholar] [CrossRef]
- Uchida, S.; Takashima, S.; Hori, M.; Fukasawa, M.; Ohshima, K.; Nagahata, K.; Tatsumi, T. Plasma damage mechanisms for low-k porous SiOCH films due to radiation, radicals, and ions in the plasma etching process. J. Appl. Phys. 2008, 103, 073303. [Google Scholar] [CrossRef]
- Takeda, K.; Miyawaki, Y.; Takashima, S.; Fukasawa, M.; Oshima, K.; Nagahata, K.; Tatsumi, T.; Hori, M. Mechanism of plasma-induced damage to low–k SiOCH films during plasma ashing of organic resists. J. Appl. Phys. 2011, 109, 033303. [Google Scholar] [CrossRef]
- Rakhimova, T.V.; Rakhimov, A.T.; Mankelevich, Y.A.; Lopaev, D.V.; Kovalev, A.S.; Vasil’eva, A.N.; Zyryanov, S.M.; Kurchikov, K.; Proshina, O.V.; Voloshin, D.G.; et al. Low–k films modification under EUV and VUV radiation. J. Phys. D Appl. Phys. 2013, 47, 025102. [Google Scholar] [CrossRef]
- Nichols, M.T.; Sinha, H.; Wiltbank, C.A.; Antonelli, G.A.; Nishi, Y.; Shohet, J.L. Time-dependent dielectric breakdown of plasma-exposed porous organosilicate glass. Appl. Phys. Lett. 2012, 100, 112905. [Google Scholar] [CrossRef]
- Nichols, M.T.; Mavrakakis, K.; Lin, Q.; Shohet, J.L. The effects of plasma exposure and vacuum ultraviolet irradiation on photopatternable low–k dielectric materials. J. Appl. Phys. 2013, 114, 104107. [Google Scholar] [CrossRef]
- Ren, H.; Nichols, M.T.; Jiang, G.; Antonelli, G.A.; Nishi, Y.; Shohet, J.L. Defects in low–k organosilicate glass and their response to processing as measured with electron-spin resonance. Appl. Phys. Lett. 2011, 98, 102903. [Google Scholar] [CrossRef]
- Bittel, B.C.; Lenahan, P.M.; King, S.W. Ultraviolet radiation effects on paramagnetic defects in low–k dielectrics for ultralarge scale integrated circuit interconnects. Appl. Phys. Lett. 2010, 97, 063506. [Google Scholar] [CrossRef]
- Sinha, H.; Ren, H.; Nichols, M.T.; Lauer, J.L.; Tomoyasu, M.; Russell, N.M.; Jiang, G.; Antonelli, G.A.; Fuller, N.C.; Engelmann, S.U.; et al. The effects of vacuum ultraviolet radiation on low–k dielectric films. J. Appl. Phys. 2012, 112, 111101. [Google Scholar] [CrossRef]
- Ogawa, E.T.; Aubel, O. Electrical breakdown in advanced interconnect dielectrics. In Advanced Interconnects for ULSI Technology; Baklanov, M., Ho, P.S., Zschech, E., Eds.; John Wiley & Sons: Hoboken, NJ, USA, 2012; pp. 369–434. [Google Scholar] [CrossRef]
- Y Barbarin, Y.; Croes, K.; Roussel, P.J.; Li, Y.; Verdonck, P.; Baklanov, M.; Tokei, Zs.; Zhao, L. Reliability characteristics of thin porous low-k silica-based interconnect dielectrics. In Proceedings of the 2013 IEEE International Reliability Physics Symposium (IRPS), Monterey, CA, USA, 14–18 April 2013; 2F.3.1–2F.3.6. IEEE. [Google Scholar] [CrossRef]
- Wu, C.; Li, Y.; Baklanov, M.R.; Croes, K. Electrical reliability challenges of advanced low-k dielectrics. ECS J. Solid State Sci. Technol. 2014, 4, N3065–N3070. [Google Scholar] [CrossRef]
- Suzumura, N.; Yamamoto, S.; Kodama, D.; Makabe, K.; Komori, J.; Murakami, E.; Maegawa, S.; Kubota, K. A new TDDB degradation model based on Cu ion drift in Cu interconnect dielectrics. In 2006 IEEE International Reliability Physics Symposium Proceedings; IEEE: Piscataway, NJ, USA, 2006; pp. 484–489. [Google Scholar] [CrossRef]
- Tokei, Z.; Sutcliffe, V.; Demuynck, S.; Iacopi, F.; Roussel, P.; Beyer, G.P.; Hoofman, R.J.O.M.; Maex, K. Impact of the barrier/dielectric interface quality on reliability of Cu porous-low-k interconnects. In 2004 IEEE International Reliability Physics Symposium Proceedings; IEEE: Piscataway, NJ, USA, 2004; pp. 326–332. [Google Scholar] [CrossRef]
- Baklanov, M.R.; Gismatulin, A.A.; Naumov, S.; Perevalov, T.V.; Gritsenko, V.A.; Vishnevskiy, A.S.; Rakhimova, T.V.; Vorotilov, K.A. Comprehensive Review on the Impact of Chemical Composition, Plasma Treatment, and Vacuum Ultraviolet (VUV) Irradiation on the Electrical Properties of Organosilicate Films. Polymers 2024, 16, 2230. [Google Scholar] [CrossRef] [PubMed]
- Agmon, N. The Grotthuss mechanism. Chem. Phys. Lett. 1995, 244, 456–462. [Google Scholar] [CrossRef]
- King, S.W.; Bielefeld, J.; Xu, G.; Lanford, W.A.; Matsuda, Y.; Dauskardt, R.H.; Kim, N.; Hondongwa, D.; Olasov, L.; Daly, B.; et al. Influence of network bond percolation on the thermal, mechanical, electrical and optical properties of high and low-k a-SiC:H thin films. J. Non-Cryst. Solids 2013, 379, 67–79. [Google Scholar] [CrossRef]
- Gerelt-Od, M.; Kolesnikova, T.G.; Mokrushev, P.A.; Vishnevskiy, A.S.; Vorotilov, K.A.; Gismatulin, A.A.; Gritsenko, V.A.; Baklanov, M.R. Exploring the relationship between electrical characteristics and changes in chemical composition and structure of OSG low-k films under thermal annealing. Coatings 2024, 14, 1412. [Google Scholar] [CrossRef]
- Gerelt-Od, M.; Vishnevskiy, A.; Konyakhin, F.; Lopaev, D.; Vorotilov, K.; Baklanov, M. Utilizing porous low-k dielectrics for self-monitoring of vacuum chamber contamination during UV annealing. In Proceedings of the International Conference on Micro and Nanoelectronics (ICMNE’2025), Yaroslavl, Russia, October 2025. [Google Scholar]
- Zheng, H.; Guo, X.; Pei, D.; Ryan, E.T.; Nishi, Y.; Shohet, J.L. Effects of vacuum ultraviolet irradiation on trapped charges and leakage currents of low-k organosilicate dielectrics. Appl. Phys. Lett. 2015, 106, 192902. [Google Scholar] [CrossRef]
- Ren, H.; Jiang, G.; Antonelli, G.A.; Nishi, Y.; Shohet, J.L. The nature of the defects generated from plasma exposure in pristine and ultraviolet-cured low-k organosilicate glass. Appl. Phys. Lett. 2011, 98, 251906. [Google Scholar] [CrossRef]
- Vanstreels, K.; Ciofi, I.; Barbarin, Y.; Baklanov, M.R. Influence of porosity on dielectric breakdown of ultralow-k dielectrics. J. Vac. Sci. Technol. B 2013, 31, 051202. [Google Scholar] [CrossRef]
- Urbanowicz, A.M.; Vanstreels, K.; Verdonck, P.; Shamiryan, D.; De Gendt, S.; Baklanov, M.R. Improving mechanical robustness of ultralow-k SiOCH plasma enhanced chemical vapor deposition glasses by controlled porogen decomposition prior to UV-hardening. J. Appl. Phys. 2010, 107, 104104. [Google Scholar] [CrossRef]
- Ogawa, E.T.; Kim, J.; Haase, G.S.; Mogul, H.C.; McPherson, J.W. Leakage, breakdown, and TDDB characteristics of porous low-k silica-based interconnect dielectrics. In 2003 IEEE International Reliability Physics Symposium Proceedings, 41st Annual; IEEE: Piscataway, NJ, USA, 2003; pp. 166–172. [Google Scholar] [CrossRef]
- Lee, S.C.; Oates, A.S. Reliability limitations to the scaling of porous low-k dielectrics. In 2011 International Reliability Physics Symposium; IEEE: Piscataway, NJ, USA, 2011. [Google Scholar] [CrossRef]
- Li, Y.; Ciofi, I.; Carbonell, L.; Heylen, N.; Van Aelst, J.; Baklanov, M.R.; Groeseneken, G.; Maex, K.; Tőkei, Z. Influence of absorbed water components on SiOCH low-k reliability. J. Appl. Phys. 2008, 104, 034104. [Google Scholar] [CrossRef]
- Jinnai, B.; Nozawa, T.; Samukawa, S. Damage mechanism in low-dielectric (low-k) films during plasma processes. J. Vac. Sci. Technol. B 2008, 26, 1926–1932. [Google Scholar] [CrossRef]
- Van Besien, E.; Pantouvaki, M.; Zhao, L.; De Roest, D.; Baklanov, M.R.; Tőkei, Z.; Beyer, G. Influence of porosity on electrical properties of low-k dielectrics. Microelectron. Eng. 2012, 92, 59–61. [Google Scholar] [CrossRef]
- Hong, C.; Milor, L. Effect of porosity on charge transport in porous ultra-low-k dielectrics. In 2006 International Interconnect Technology Conference; IEEE: Piscataway, NJ, USA, 2006; pp. 140–142. [Google Scholar] [CrossRef]
- Lloyd, J.R.; Murray, C.E.; Ponoth, S.; Cohen, S.; Liniger, E. The effect of Cu diffusion on the TDDB behavior in low-k interlevel dielectrics. Microelectron. Reliab. 2006, 46, 1643–1647. [Google Scholar] [CrossRef]
- Michelon, J.; Hoofman, R.J. Moisture influence on porous low-k reliability. IEEE Trans. Device Mater. Reliab. 2006, 6, 169–174. [Google Scholar] [CrossRef]
- Lee, S.C.; Oates, A.S.; Chang, K.M. Fundamental understanding of porous low-k dielectric breakdown. In 2009 IEEE International Reliability Physics Symposium; IEEE: Piscataway, NJ, USA, 2009; pp. 481–485. [Google Scholar] [CrossRef]
- Miyazaki, H.; Kodama, D.; Suzumura, N. The observation of stress-induced leakage current of damascene interconnects after bias temperature aging. In 2008 IEEE International Reliability Physics Symposium; IEEE: Piscataway, NJ, USA, 2008; pp. 150–157. [Google Scholar] [CrossRef]
- Wu, C.; Li, Y.; Barbarin, Y.; Ciofi, I.; Croes, K.; Bömmels, J.; De Wolf, I.; Tőkei, Z. Correlation between field dependent electrical conduction and dielectric breakdown in a SiCOH based low-k (k = 2.0) dielectric. Appl. Phys. Lett. 2013, 103, 032902. [Google Scholar] [CrossRef]
- Wu, E.Y.; Vollertsen, R.P. On the Weibull shape factor of intrinsic breakdown of dielectric films and its accurate experimental determination. Part I: Theory, methodology, experimental techniques. IEEE Trans. Electron Devices 2003, 49, 2131–2140. [Google Scholar] [CrossRef]
- Ogawa, E.T.; McPherson, J.W.; Rosal, J.A.; Dickerson, K.J.; Chiu, T.C.; Tsung, L.Y.; Jain, M.K.; Bonifield, T.D.; Ondrusek, J.C.; McKee, W.R. Stress-induced voiding under vias connected to wide Cu metal leads. In 2002 IEEE International Reliability Physics Symposium Proceedings, 40th Annual (Cat. No. 02CH37320); IEEE: Piscataway, NJ, USA, 2002; pp. 312–321. [Google Scholar] [CrossRef]
- Hong, C.; Milor, L. Electric field enhancement caused by porosity in ultra-low-k dielectrics. In ISSM 2005, IEEE International Symposium on Semiconductor Manufacturing; IEEE: Piscataway, NJ, USA, 2005; pp. 434–437. [Google Scholar] [CrossRef]
- Orlov, A.A.; Rezvanov, A.A.; Gvozdev, V.A.; Orlov, G.A.; Seregin, D.S.; Kuznetsov, P.I.; Blumberg, T.; Veselov, A.A.; Suzuki, T.; Morozov, E.N.; et al. Dielectric barrier in the subtractive process of formation of a copper metallization system. Russ. Microelectron. 2022, 51, 470–479. [Google Scholar] [CrossRef]
- Chen, F.; Li, B.; Lee, T.; Christiansen, C.; Gill, J.; Angyal, M.; Shinosky, M.; Burke, C.; Hasting, W.; Austin, R.; et al. Technology reliability qualification of a 65nm CMOS Cu/low-k BEOL interconnect. In 2006 13th International Symposium on the Physical and Failure Analysis of Integrated Circuits; IEEE: Piscataway, NJ, USA, 2006; pp. 97–105. [Google Scholar] [CrossRef]
- Paquette, M.M.; Nordell, B.J.; Caruso, A.N.; Sato, M.; Fujiwara, H.; King, S.W. Optimization of amorphous semiconductors and low-/high-k dielectrics through percolation and topological constraint theory. MRS Bull. 2017, 42, 39–44. [Google Scholar] [CrossRef]
- Armini, S.; Prado, J.L.; Krishtab, M.; Swerts, J.; Verdonck, P.; Meersschaut, J.; Conard, T.; Blauw, M.; Struyf, H.; Baklanov, M.R. Pore sealing of k 2.0 dielectrics assisted by self-assembled monolayers deposited from vapor phase. Microelectron. Eng. 2014, 120, 240–245. [Google Scholar] [CrossRef]
- Zhao, L.; Tokei, Z.; Gischia, G.G.; Pantouvaki, M.; Croes, K.; Beyer, G. A novel test structure to study intrinsic reliability of barrier/low-k. In 2009 IEEE International Reliability Physics Symposium; IEEE: Piscataway, NJ, USA, 2009; pp. 848–850. [Google Scholar] [CrossRef]
- Frot, T.; Volksen, W.; Purushothaman, S.; Bruce, R.; Dubois, G. Application of the Protection/Deprotection Strategy to the Science of Porous Materials. Adv. Mater. 2011, 23(25), 2828–2832. [Google Scholar] [CrossRef] [PubMed]
- Frot, T.; Volksen, W.; Purushothaman, S.; Bruce, R.L.; Magbitang, T.; Miller, D.C.; Sherwood, M.H.; Dubois, G. Post Porosity Plasma Protection: Scaling of Efficiency with Porosity. Adv. Funct. Mater. 2012, 22(14), 3043–3050. [Google Scholar] [CrossRef]
- Zhang, L.; Ljazouli, R.; Lefaucheux, P.; Tillocher, T.; Dussart, R.; Mankelevich, Y.A.; de Marneffe, J.-F.; de Gendt, S.; Baklanov, M.R. Low damage cryogenic etching of porous organosilicate low-k materials using SF₆/O₂/SiF₄. ECS J. Solid State Sci. Technol. 2013, 2, N131–N139. [Google Scholar] [CrossRef]
- Vanstreels, K.; Li, H.; Vlassak, J.J. Mechanical reliability of low-k dielectrics. In Advanced Interconnects for ULSI Technology, 1st Ed.; Baklanov, M.R., Ho P., Zschech, E., Eds.; Springer: New York, NY, USA, 2012, 10, 339–367. [Google Scholar] [CrossRef]
- Phillips, J. C.; Thorpe, M. F. Constraint Theory, Vector Percolation and Glass Formation. Solid State Commun. 1985, 53(8), 699–702. [Google Scholar] [CrossRef]
- Burkey, D.D.; Gleason, K.K. Structure and mechanical properties of thin films deposited from 1,3,5-trimethyl-1,3,5-trivinylcyclotrisiloxane and water. J. Appl. Phys. 2003, 93, 5143–5150. [Google Scholar] [CrossRef]
- Ross, D. Chemical vapor deposition of Organosilicon composite thin films for porous low-k films. PhD thesis, MIT, USA, 2005.
- Plawsky, J.L.; Achanta, R.; Cho, W.; Rodriguez, O.; Saxena, R.; Gill, W.N. Mechanical and transport properties of low-k dielectrics. In Dielectric Films for Advanced Microelectronics; Baklanov, M.R., Green, M., Maex, K., Eds.; John Wiley & Sons: NY, USA, 2007; pp. 137–197. [Google Scholar] [CrossRef]
- Ashby, M.F.; Gibson, L.J. Cellular solids: structure and properties; Press Syndicate of the University of Cambridge: Cambridge, UK, 1997; pp. 175–231. [Google Scholar]
- Hashin, Z.; Shtrikman, S. A variational approach to the theory of the elastic behaviour of multiphase materials. J. Mech. Phys. Solids 1963, 11, 127–140. [Google Scholar] [CrossRef]
- Vanstreels, K.; Wu, C.; Baklanov, M.R. Mechanical stability of porous low-k dielectrics. ECS J. Solid State Sci. Technol. 2014, 4, N3058–N3064. [Google Scholar] [CrossRef]
- Farago, O.; Kantor, Y. Entropic elasticity of phantom percolation networks. Europhys. Lett. 2000, 52, 413–419. [Google Scholar] [CrossRef]
- Rice, R.W. Use of normalized porosity in models for the porosity dependence of mechanical properties. J. Mater. Sci. 2005, 40, 983–989. [Google Scholar] [CrossRef]
- Kováčik, J. Correlation between Young’s modulus and porosity in porous materials. J. Mater. Sci. Lett. 1999, 18, 1007–1010. [Google Scholar] [CrossRef]
- Stauffer, D.; Aharony, A. Introduction to Percolation Theory; Taylor & Francis: London, UK, 2018. [Google Scholar]
- Yeap, K.B.; Kopycinska-Mueller, M.; Chen, L.; Chen, Y.; Jungmann, M.; Krause-Rehberg, R.; Mahajan, S.; Vlassak, J.; Gall, M.; Zschech, E. The effect of the pore topology on the elastic modulus of organosilicate glasses. J. Mater. Res. 2013, 28, 1262–1268. [Google Scholar] [CrossRef]
- Michalak, D.J.; Blackwell, J.M.; Torres, J.M.; Gleason, K.K.; Grill, A.; Le, Q.T.; Gates, S.M.; Neumayer, D.A.; Noori, A.M.; Smith, B.C.; Weigand, S.J. Porosity Scaling Strategies for Low-k Films. J. Mater. Res. 2015, 30, 3363–3385. [Google Scholar] [CrossRef]
- Li, H.; Lin, Y.; Tsui, T.Y.; Vlassak, J.J. The effect of porogen loading on the stiffness and fracture energy of brittle organosilicates. J. Mater. Res. 2009, 24, 107–116. [Google Scholar] [CrossRef]
- Burg, J.A.; Oliver, M.S.; Frot, T.J.; Sherwood, M.; Lee, V.; Dubois, G.; Dauskardt, R.H. Hyperconnected molecular glass network architectures with exceptional elastic properties. Nat. Commun. 2017, 8, 1019. [Google Scholar] [CrossRef]
- King, S.W.; Bielefeld, J.; Xu, G.; Lanford, W.A.; Matsuda, Y.; Dauskardt, R.H.; Kim, N.; Hondongwa, D.; Olasov, L.; Daly, B.; et al. Influence of network bond percolation on the thermal, mechanical, electrical and optical properties of high and low-k a-SiC:H thin films. J. Non-Cryst. Solids 2013, 379, 67–79. [Google Scholar] [CrossRef]
- Kilic, K.I.; Dauskardt, R.H. Design of Ultrastiff Organosilicate Hybrid Glasses. Adv. Funct. Mater. 2019, 29(44), 1904890. [Google Scholar] [CrossRef]
- Kilic, K.I.; Dauskardt, R.H. Mechanically Reliable Hybrid Organosilicate Glasses for Advanced Interconnects. J. Vac. Sci. Technol. B 2020, 38, 06FK01. [Google Scholar] [CrossRef]
- De Keer, L.; Kilic, K.I.; Van Steenberge, P.H.; Daelemans, L.; Kodura, D.; Frisch, H.; De Clerck, K.; Reyniers, M.-F.; Barner-Kowollik, C.; Dauskardt, R.H.; et al. Computational Prediction of the Molecular Configuration of Three-Dimensional Network Polymers. Nat. Mater. 2021, 20, 1422–1430. [Google Scholar] [CrossRef] [PubMed]
- Rasadujjaman, M.; Wang, X.; Wang, Y.; Zhang, J.; Arkhincheev, V.E.; Baklanov, M.R. Analytical study of porous organosilicate glass films prepared from mixtures of 1,3,5- and 1,3-alkoxysilylbenzenes. Materials 2021, 14, 1881. [Google Scholar] [CrossRef] [PubMed]
- Broadbent, S.R.; Hammersley, J.M. Percolation processes: I. Crystals and mazes. Math. Proc. Camb. Philos. Soc. 1957, 53, 629–641. [Google Scholar] [CrossRef]
- Kesten, H. The critical probability of bond percolation on the square lattice equals 1/21/21/2. Commun. Math. Phys. 1980, 74, 41–59. [Google Scholar] [CrossRef]
- Aizenman, M.; Barsky, D.J. Sharpness of the Phase Transition in Percolation Models. Commun. Math. Phys. 1987, 108, 489–526. [Google Scholar] [CrossRef]
- Grimmett, G.R. Inequalities and entanglements for percolation and random-cluster models. In Perplexing Problems in Probability: Festschrift in Honor of Harry Kesten; Birkhäuser: Boston, MA, 1999; pp. 91–105. [Google Scholar] [CrossRef]
- Grassberger, P. On the Critical Behavior of the General Epidemic Process and Dynamical Percolation. Math. Biosci. 1983, 63, 157–172. [Google Scholar] [CrossRef]
- Cohen, R.; Havlin, S. Complex Networks: Structure, Robustness and Function; Cambridge University Press: Cambridge, UK, 2010. [Google Scholar]
- Sahimi, M. Flow and Transport in Porous Media and Fractured Rock: From Classical Methods to Modern Approaches; John Wiley & Sons: Hoboken, NJ, USA, 2011. [Google Scholar]
- Newman, M.E.J. Spread of epidemic disease on networks. Phys. Rev. E 2002, 66, 016128. [Google Scholar] [CrossRef]
- Beggs, J.M.; Plenz, D. Neuronal avalanches in neocortical circuits. J. Neurosci. 2003, 23, 11167–11177. [Google Scholar] [CrossRef] [PubMed]
- Gupta, P.; Kumar, P.R. The capacity of wireless networks. IEEE Trans. Inf. Theory 2000, 46, 388–404. [Google Scholar] [CrossRef]
- Achlioptas, D.; D’Souza, R.M.; Spencer, J. Explosive percolation in random networks. Science 2009, 323, 1453–1455. [Google Scholar] [CrossRef] [PubMed]
- De Gennes, P.G. Scaling Concepts in Polymer Physics; Cornell University Press: Ithaca, NY, USA, 1979. [Google Scholar]
- Ashby, M.F.; Medalist, R.M. The Mechanical Properties of Cellular Solids; Pergamon Press: Oxford, UK, 1983. [Google Scholar] [CrossRef]
- Gibson, I.J.; Ashby, M.F. The Mechanics of Three-Dimensional Cellular Materials. Proc. R. Soc. Lond. A 1982, 382, 43–59. [Google Scholar] [CrossRef]
- Gibson, L.J.; Ashby, M.F.; Schajer, G.S.; Robertson, C.I. The Mechanics of Two-Dimensional Cellular Materials. Proc. R. Soc. Lond. A 1982, 382, 25–42. [Google Scholar] [CrossRef]
- Deshpande, V.S.; Ashby, M.F.; Fleck, N.A. Foam Topology: Bending versus Stretching Dominated Architectures. Acta Mater. 2001, 49, 1035–1040. [Google Scholar] [CrossRef]
- Efros, A.L.; Shklovskii, B.I. Critical Behaviour of Conductivity and Dielectric Constant Near the Metal-Non-Metal Transition Threshold. Phys. Status Solidi B 1976, 76, 475–485. [Google Scholar] [CrossRef]
- Clerc, J.P.; Giraud, G.; Laugier, J.M.; Luck, J.M. The Electrical Conductivity of Binary Disordered Systems, Percolation Clusters, Fractals and Related Models. Adv. Phys. 1990, 39, 191–309. [Google Scholar] [CrossRef]
- Bergman, D.J.; Stroud, D. Physical Properties of Macroscopically Inhomogeneous Media. In Solid State Physics; Academic Press: San Diego, CA, USA, 1992; Volume 46, pp. 147–269. [Google Scholar] [CrossRef]
- Kumar, A.; Vidhyadhiraja, N.S.; Kulkarni, G.U. Current distribution in conducting nanowire networks. J. Appl. Phys. 2017, 122, 043705. [Google Scholar] [CrossRef]
- Mandelbrot, B.B. Fractals: Form, Chance, and Dimension; W. H. Freeman and Company: New York, NY, USA, 2020. [Google Scholar]
- Richardson, L.F. The Problem of Contiguity: An Appendix to Statistics of Deadly Quarrels. General Systems Yearbook 1961, 6, 139–187. [Google Scholar]
- Addison, P.S. Fractals and Chaos: An Illustrated Course; CRC Press: Boca Raton, FL, USA, 1997. [Google Scholar]
- Weiss, G.H.; Havlin, S. Some properties of a random walk on a comb structure. Physica A 1986, 134, 474–482. [Google Scholar] [CrossRef]
- Havlin, S.; Kiefer, J.E.; Weiss, G.H. Anomalous diffusion on a random comblike structure. Phys. Rev. A 1987, 36, 1403. [Google Scholar] [CrossRef]
- Murthy, K.P.N.; Kehr, K.W. Mean first-passage time of random walks on a random lattice. Phys. Rev. A 1989, 40, 2082. [Google Scholar] [CrossRef] [PubMed]
- Arkhincheev, V.E.; Baskin, E.M. Anomalous diffusion and drift in a comb model of percolation clusters. Sov. Phys. JETP 1991, 73, 161–300. [Google Scholar]
- Arkhincheev, V. E. Diffusion on random comb structure: effective medium approximation. Physica A 2002, 307, 131–141. [Google Scholar] [CrossRef]
- Lubashevskii, I. A.; Zemlyanov, A. A. Continuum description of anomalous diffusion on a comb structure. J. Exp. Theor. Phys. 1998, 87, 700–713. [Google Scholar] [CrossRef]
- Alexander, S.; Orbach, R. Density of states on fractals: “fractons”. J. Phys. Lett. 1982, 43, 625–631. [Google Scholar] [CrossRef]
- Gefen, Y.; Aharony, A.; Mandelbrot, B.B.; Kirkpatrick, S. Solvable fractal family, and its possible relation to the backbone at percolation. Phys. Rev. Lett. 1981, 47, 1771. [Google Scholar] [CrossRef]
- Chamon, C. Quantum glassiness in strongly correlated clean systems: An example of topological overprotection. Phys. Rev. Lett. 2005, 94, 040402. [Google Scholar] [CrossRef] [PubMed]
- Haah, J. Local stabilizer codes in three dimensions without string logical operators. Phys. Rev. A 2011, 83, 042330. [Google Scholar] [CrossRef]
- Nandkishore, R.M.; Hermele, M. Fractons. Annu. Rev. Condens. Matter Phys. 2019, 10, 295–313. [Google Scholar] [CrossRef]


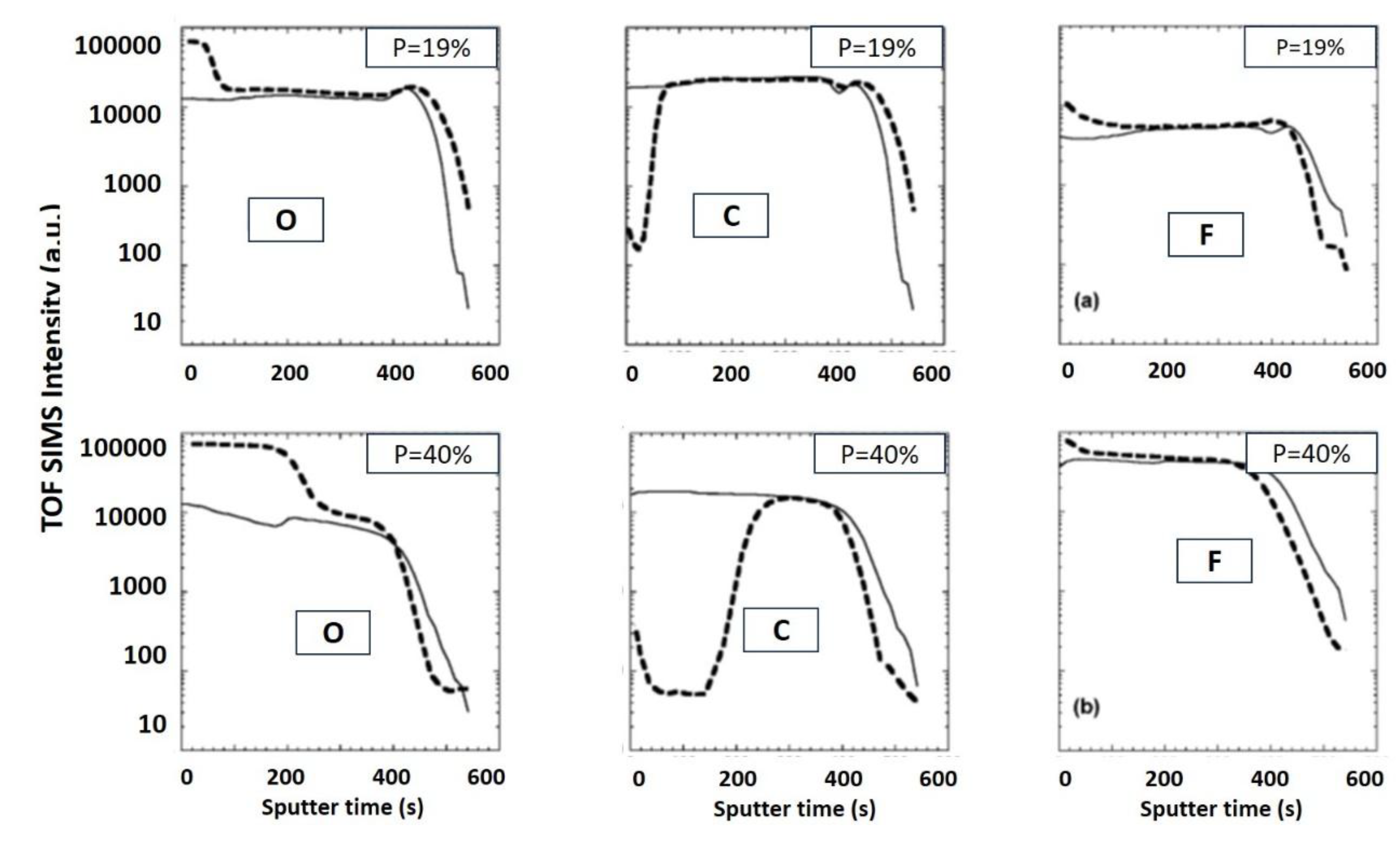
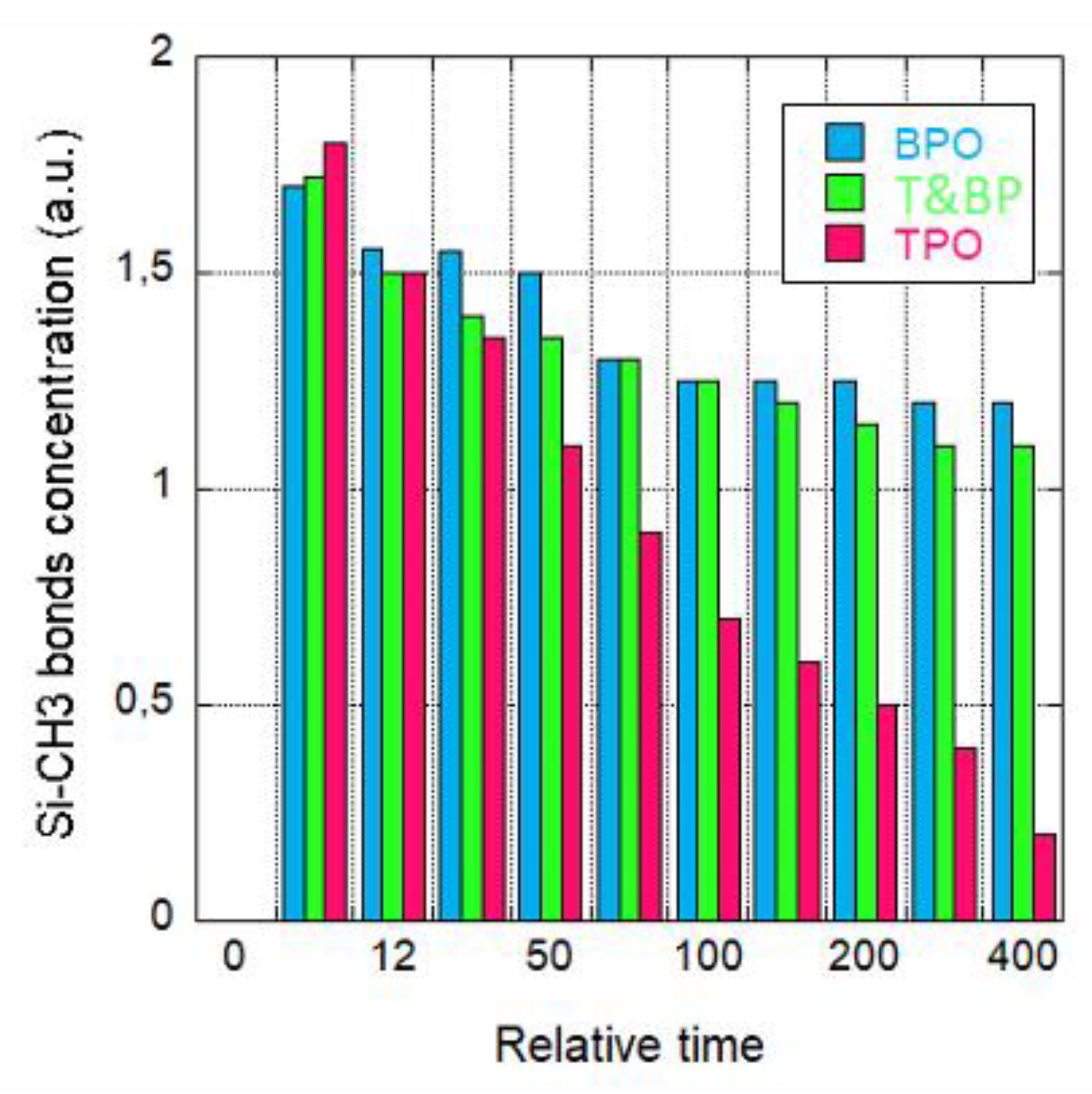
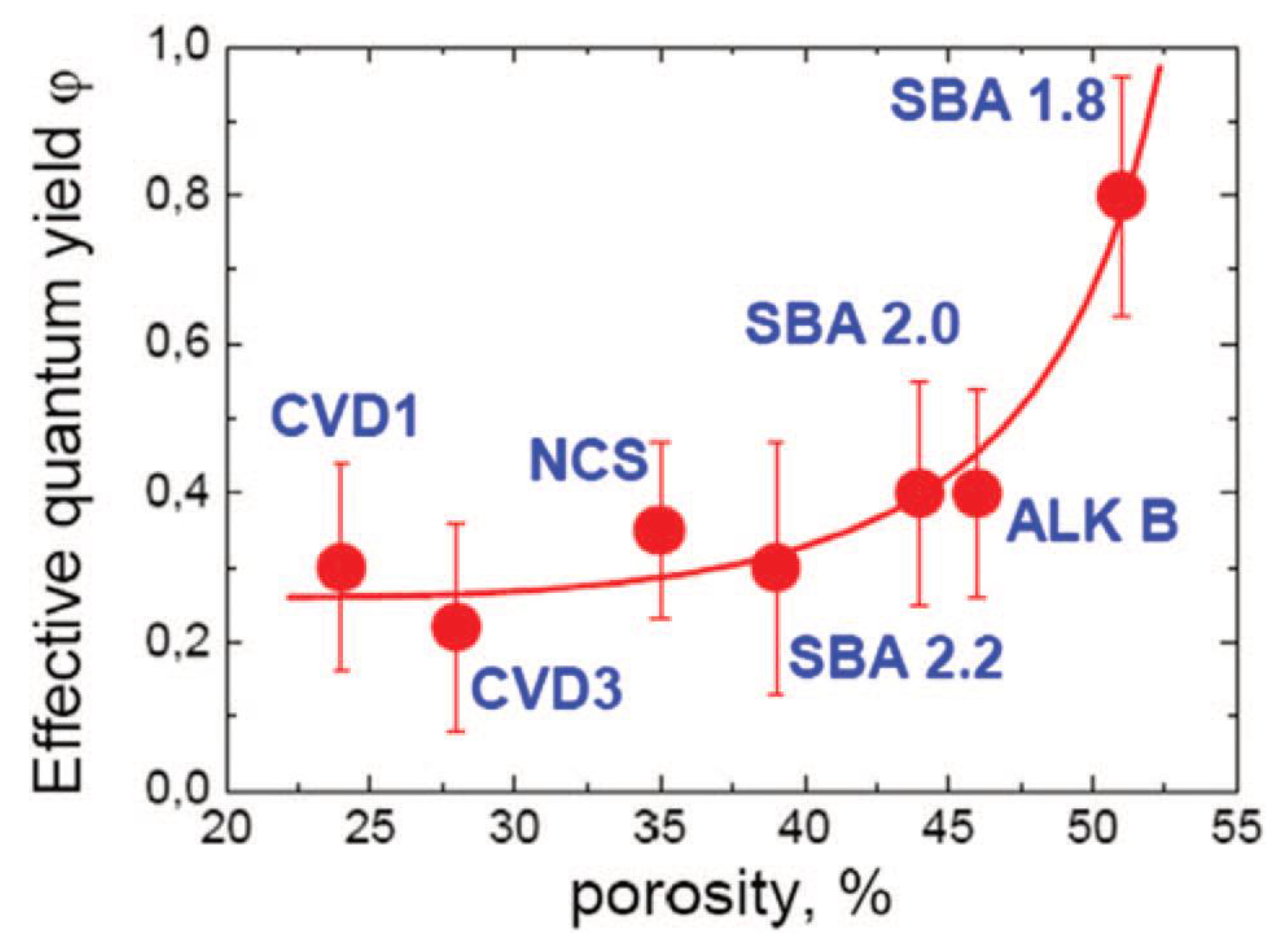


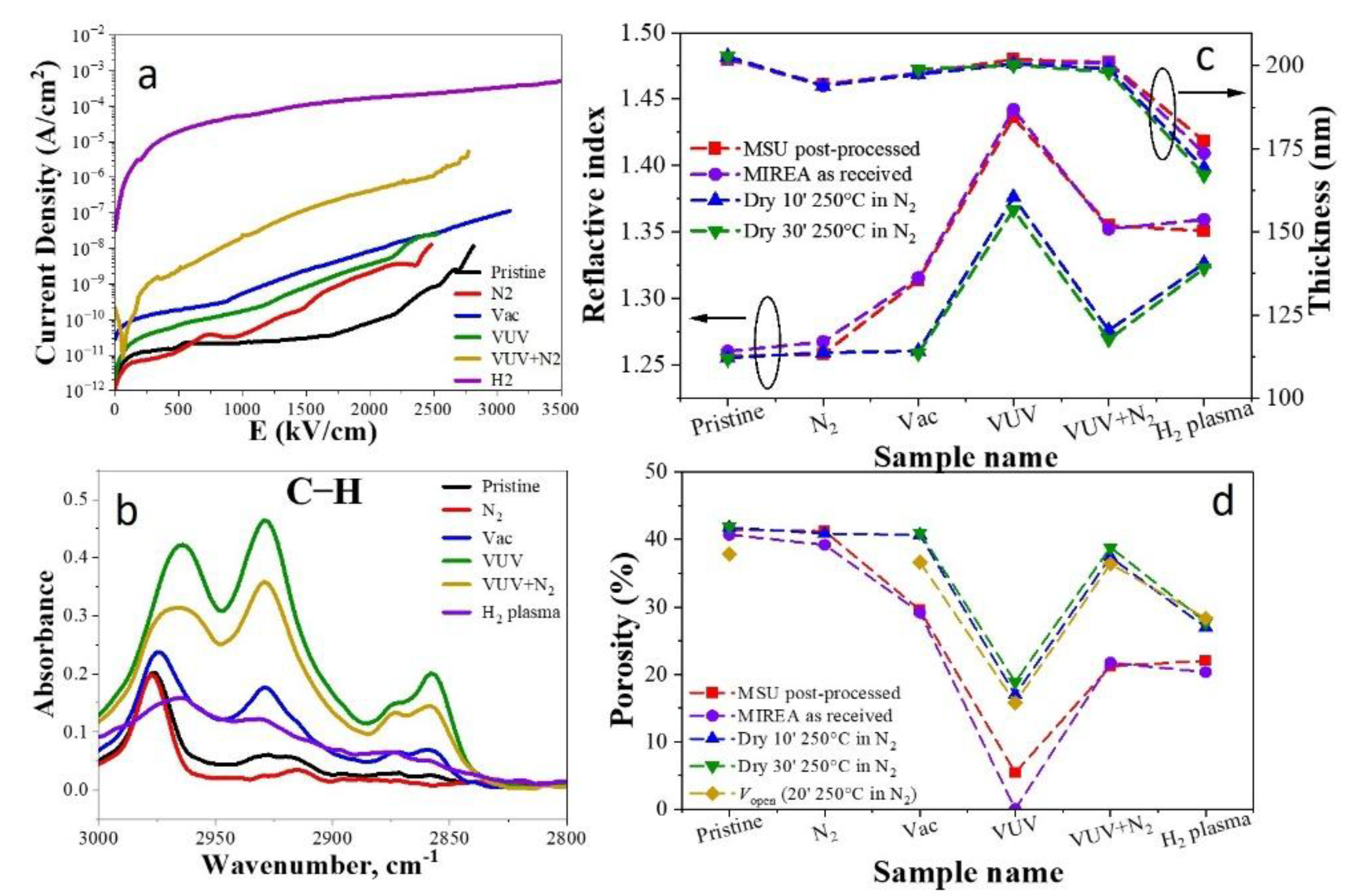
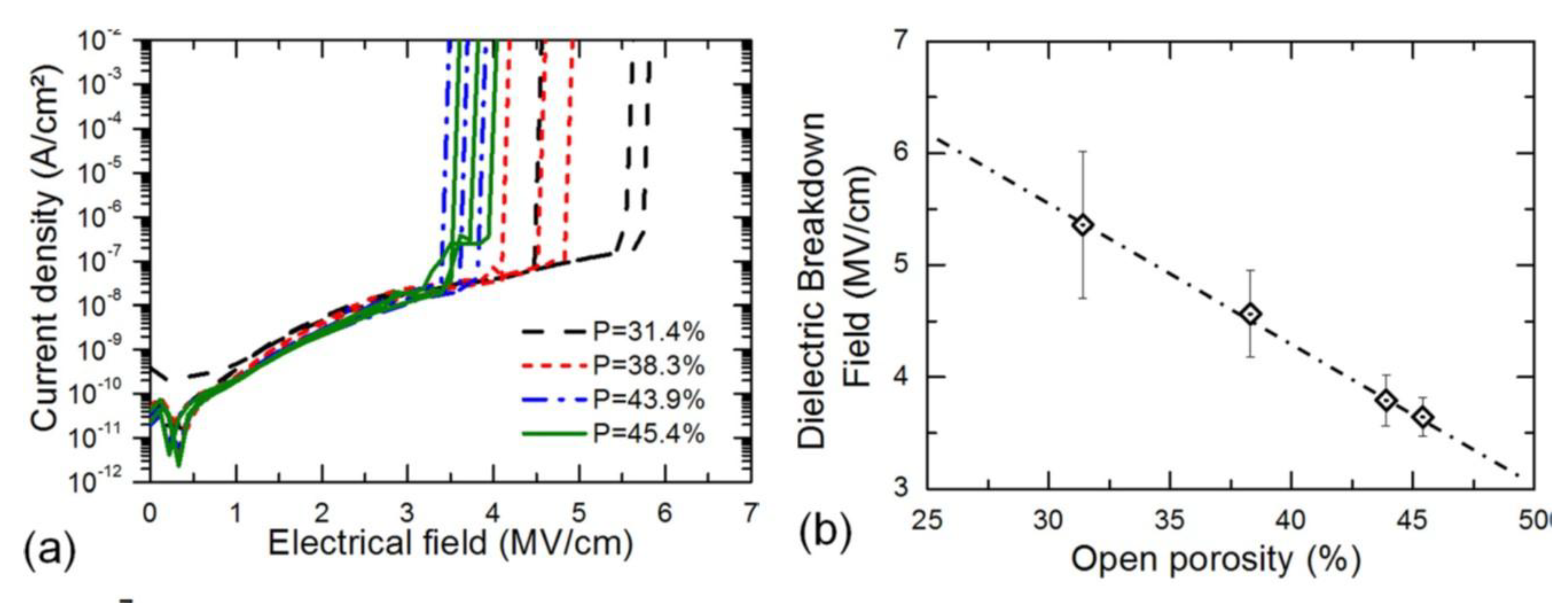
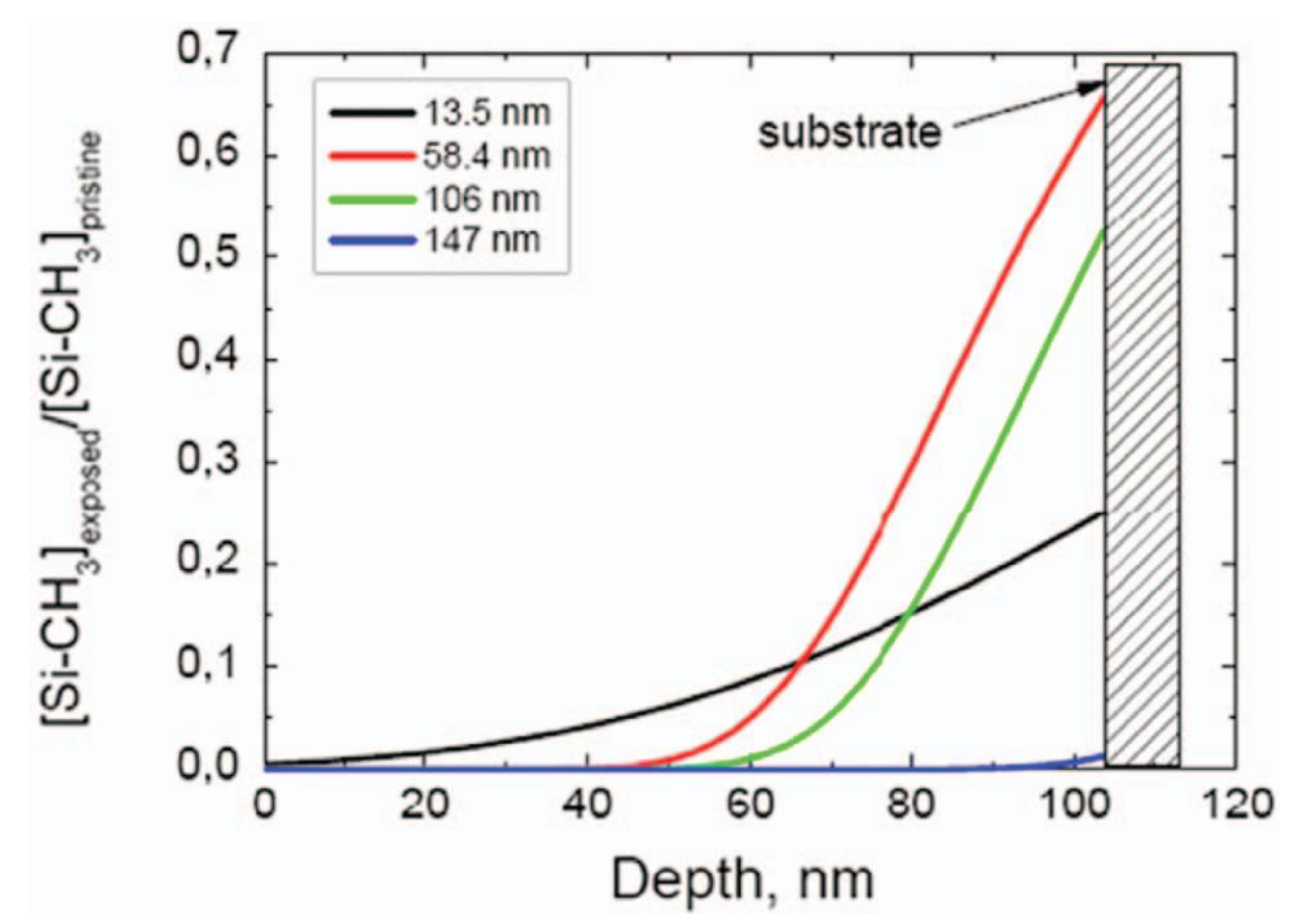
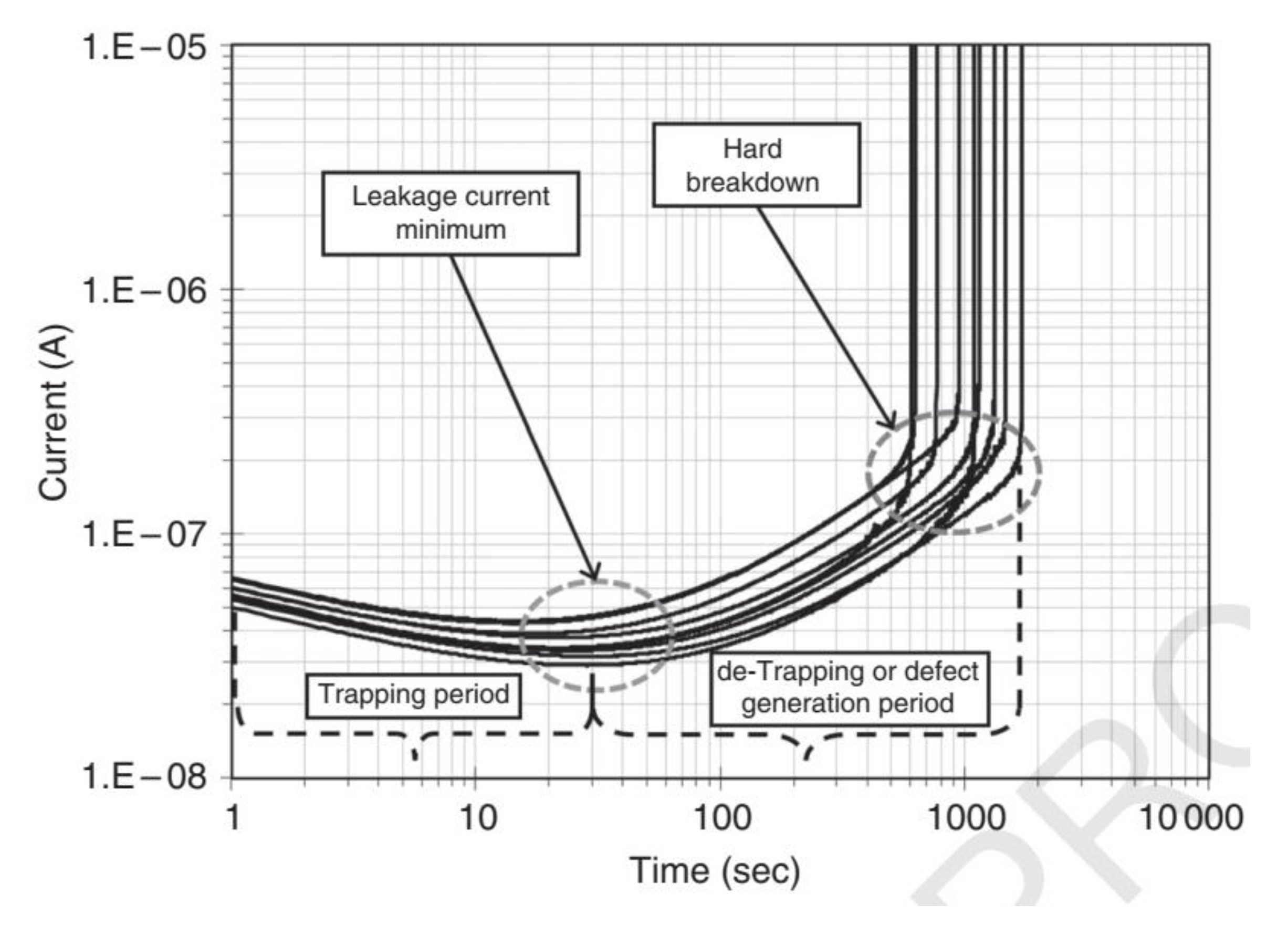

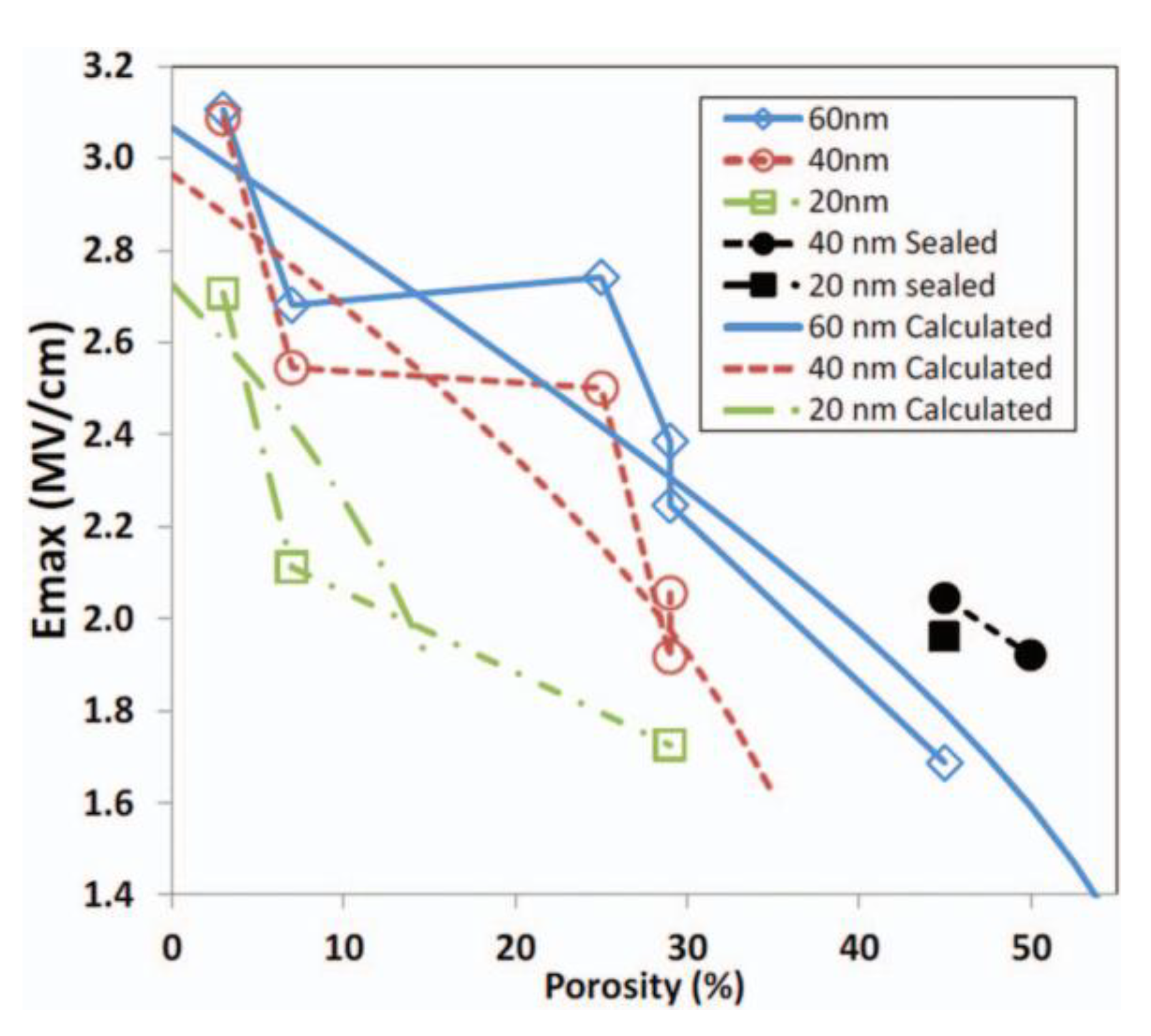

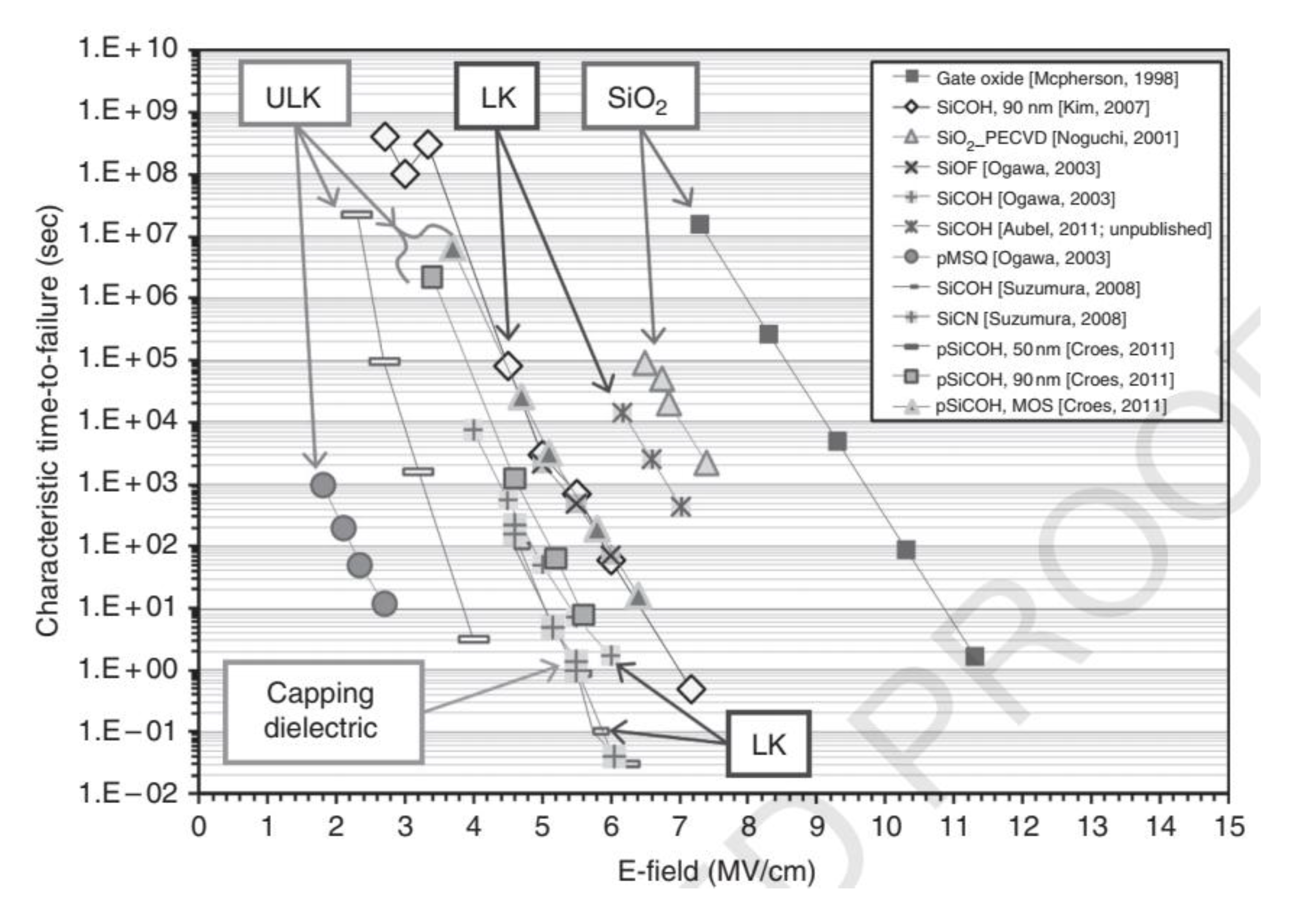
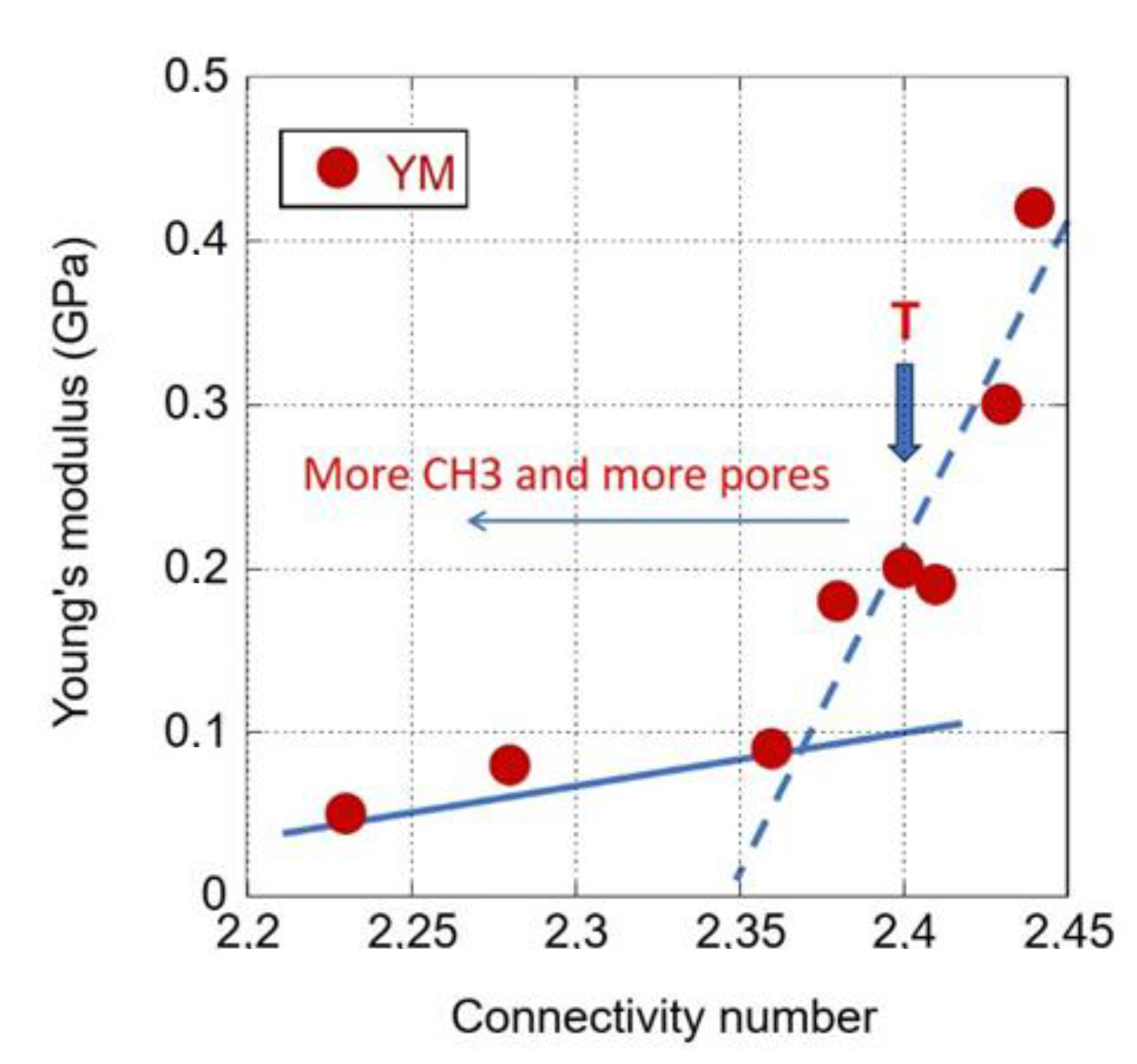



| Material | Type | k-value |
Porosity (%) |
Deposition | Integration | Technology Nodes |
| FOX | Fluorinated SiO₂ | 3.0–3.6 | Dense | Spin-on | Yes | 180 nm, 130 nm |
| BD1 | OSG | ~3.0 | <10 | PECVD | Yes | 90 nm, 65 nm |
| BDII | OSG | ~2.5 | ~25 | PECVD | Yes | 65 nm, 45 nm, 32 nm |
| SiLK, Flare |
Organic polymer | ~2.6 | Dense | Spin-on | No | Rejected (too high CTE) |
| XLK, LKD | OSG | ~ 2.0–2.3 | ~50 | Spin-on | No | Experimental |
| NCS | OSG | ~ 2.0–2.3 | ~35–40 | Spin-on | Limited (Fujitsu) |
Experimental |
| BD3 | OSG | ~ 2.2 | ~ 40–45 | PECVD | No | Experimental |
| Property | Dense OSG | Porous OSG |
| Dielectric constant (k) | 2.8–3.1 | <2.5 (ultra- low-k) |
| Breakdown field | High (4–8 MV/cm) | Moderate–low (2–4 MV/cm) |
| Leakage current | Very low | High (exponential surge at pc) |
| Moisture uptake | Minimal | High (hydrophilic pores) |
| Mechanical strength | High | Reduced (crack-prone) |
| Percolation threshold | None | 25–35% porosity |
| Property | Typical sensitivity to porosity | Percolation threshold in OSG | Main influencing factors in OSG | Remarks |
| Mass transfer | Very High | ~15–20% open porosity | Pore interconnectivity, hydrophilicity (Si–OH groups), plasma damage | Onset seen via vapor sorption, porosimetry |
| Moisture uptake | High | ~15–20% | Surface silanol density, open pores, exposure to air or plasma | Leads to permittivity drift and leakage |
| Charge transfer/ Leakage | High | ~15–25% | Moisture condensation, hydrocarbon residues, electric field-induced transport | Strongly accelerated after percolation path is filled |
| Breakdown field (EBD) | Moderate | ~20–30% | Pore alignment (vertical), moisture, carbon adsorption, Si–OH content | Degradation is non-linear and field-assisted |
| Mechanical properties | High | ~25–30% | Matrix crosslinking, Si–O–C vs. Si–O–Si ratio, pore clustering | Densely crosslinked films resist cracking longer |
| dielectric constant (k) | Moderate - (Clausius-Mossotti equation) | No sharp threshold | Total porosity, pore size | Decreases steadily with porosity |
| Mechanical Property | Typical Range | Integration Spec / Requirement | Failure Mode if Below Spec |
| Young’s Modulus | d-SiO₂: ~70 GPa; d-OSG: 8–15 GPa; p-OSG: 3–10 GPa |
≥ 4–5 GPa for CMP and packaging survivability (sub-10 nm nodes often target ~5–6 GPa) | CMP dishing/erosion, deformation under capping/barrier stress, densification → k-value increase |
| Hardness | d-SiO₂: ~8–10 GPa; p-OSG: 0.5–2 GPa |
≥ 0.5–1.0 GPa for surface wear resistance | Surface scratching, debris generation, CMP defects |
| Fracture Toughness (plane strain, KIC) | d-SiO₂: ~0.8–1.0 MPa·m1/2; p-OSG: 0.2–0.4 MPa·m1/2 |
≥ 0.25–0.3 MPa·m1/2 to prevent crack propagation | Crack initiation/propagation from packaging stress, wafer handling, or thermal cycling |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2025 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).





