Submitted:
11 February 2026
Posted:
12 February 2026
You are already at the latest version
Abstract
Keywords:
1. Introduction
2. Materials and Methods
2.1. MEMS Sensors Structure
2.2. Design and Simulation of Pressure Sensor
2.3. Design and Simulation of Temperature Sensor
2.4. Fabrication of Sensors
- (a)
- Start with a SOI wafer consisting of a 5 m device layer (100) plane with a resistivity of 0.015 -cm, a BOX layer of 2 m and a 450 m handle wafer with a resistivity of 10 -cm.
- (b)
- The SOI wafer was subjected to a dry oxidation process for 30 minutes at 1000 °C for 110 nm growth on both sides of the wafer. Then, a 100 nm chrome layer was deposited on the bottom of the wafer using sputter deposition at a rate of 0.75 Å per second for the first 25 nm, and then the rate was increased to 1.0 Å per second for a total deposition of 60 nm.
- (c)
- Structures were defined on the device layer using the Shipley’s S1813 photoresist. These include piezoresistive pressure and resistive temperature sensors, as well as supportive structures that facilitate subsequent wafer bonding procedures, as outlined in step (l). A buffered oxide etch (BOE) was used to etch the top oxide, ensuring that the defined structures remained protected by the photoresist and oxide.
- (d)
- The top device layer was etched with KOH at 82 °C until it reached the BOX layer. A slightly modified design mask, combining both triangular and rectangular structures, was used, which differed from that employed by [37].
- (e)
- A thick layer of photoresist was deposited and defined with narrower features (undersized) from the device feature mask design, to leave only narrow openings on top of the device structures. This process covered the top edges of the device structures and their exposed sidewalls, resulting from the KOH process.
- (f)
- The previous photoresist protective layer enabled to proceed with a BOE of . The photoresist thoroughly protects the bottom BOX layer, particularly at its oxide interface with the KOH machined sidewalls of the device structures.
- (g)
- After stripping the photoresist and etching the bottom chrome, the SOI wafer undergoes a piranha cleaning process. This was followed by a second dry oxidation process to grow 80 nm of . Subsequently, 100 nm of chrome was deposited on the bottom of the wafer using sputter deposition. The deposition rate was initially set at 0.75 Å per second for the first 25 nm, then increased to 1.0 Å per second for the remaining 75 nm.
- (h)
- In the next step, photoresist is used to define a sacrificial mask on the device side layer, featuring narrow openings to facilitate the BOE in the BOX layer. The layout definition of these openings is crucial for the subsequent anodic bonding process [36]. Due to the isotropic nature of the BOE, an undercut profile is formed in the BOX layer from the narrow openings in the photoresist. A 60 nm aluminum sputter deposition was then applied to the device side, allowing metal deposition on certain sections of the handle wafer through the openings in the BOX layer.
- (i)
- After cleaning the photoresist, the top metal is lifted-off, leaving only the aluminum on the BOX layer’s openings. Then, a second lift-off process was performed on the device layer to define a sacrificial layer by sputter deposition of 200 nm of chrome. This metal forms a connection between the top section of the device structures and the handle wafer through BOX openings. It is important to note that the metal maintains a continuous connection from the top section of the device structures through its micromachined sidewalls to the top face of the BOX and through the smoothly isotropic etched shape of the BOX layer to the handle wafer.
- (j)
- The SOI wafer is coated with photoresist on both sides. The photoresist on the handle wafer side is patterned, and the chrome and oxide layers on the handle wafer are etched.
- (k)
- The patterned handle wafer defines the cavity of the pressure sensor by partially etching silicon using a DRIE process. Each DRIE cycle consisted of a passivation step followed by an etching step, with specific process chamber conditions (gas flow and power settings) as follows: the passivation step used 76 sccm of , 8 W of forward RF power, and 805 W of ICP power for 5 s; the etching step employed 76 sccm of , 27 W of forward RF power, and 765 W of ICP power for 5 s. Each cycle etched an average of 0.3 m of silicon. This process defines the pressure sensor membrane, resulting in a final thickness of 190 m. Dry etching with is used to clean the remaining photoresist on the handle wafer, followed by wet etching of the chrome and oxide layers of the handle wafer.
- (l)
- The bottom layer of chrome on the handle wafer was wet etched, followed by BOE of the handle oxide layer. The photoresist from the device side was stripped, and the wafer was cleaned using the piranha process before anodic bonding of the SOI and Borofloat wafers. The metallized top layer acted as an electrode for the surrounding contacts in the pressure cavity, ensuring the proper current flow required for the anodic bonding process at the interface between the handle and glass wafers. The parameters utilized in the SB6/8 wafer bonder for the anodic bonding of the SOI and Borofloat wafers were as follows: a membrane pressure of 150 kPa, a vacuum of mBar, a temperature of 280 °C, a voltage of 1000 V, and a maximum current of 12 mA. During the bonding process, the current remained constant at 12 mA for 100 s before decreasing exponentially to 240 A after 7 min and 23 s.
- (m)
- After bonding the wafers, the sacrificial top chrome contacts were etched to prepare for the formation of ohmic contacts on the upper surface of the device structures, specifically the piezoresistive sensors.
- (n)
- A lift-off photoresist was employed to define openings in specified regions for ohmic contacts on the device layer of the pressure and temperature sensors. Subsequently, 75 nm of Al/Si (95% and 5%, respectively) was deposited at 164 °C via sputtering. The utilization of an Al/Si alloy facilitates its diffusion into silicon, thereby forming ohmic contacts.
- (o)
- After cleaning the lift-off photoresist, a new lift-off photoresist was applied to define wider openings for the ohmic contact regions on the top of the sensors. Subsequently, a second sputter deposition of 75 nm of Al/Si (95% and 5%, respectively) at 174 °C was performed.
- (p)
- A 50 nm chromium sputter deposition was used to temporarily protect the top Al/Si interface from oxidation. The lift-off photoresist was cleaned, and the bonded wafers were cleaned with piranha solution. Then, to establish ohmic contacts, thermal treatment in an inert gas environment at 450 °C for 30 min was used.
- (q)
- After the ohmic contact was formed, the oxidized top chrome was stripped off. Using photoresist for lift-off, a new 75 nm layer of sputtered chrome was deposited, followed by 250 nm of gold evaporative deposition on the device layer, culminating in a final lift-off process. Chrome and gold were smoothly deposited from the top of the device structures and connected through the machined sidewalls to define the metallized interconnections of a full Wheatstone bridge circuit. This metallization procedure was also used to connect the contact pads for wire bonding immediately after the chips were diced from the wafer. First the dicing process partially cuts the Borofloat wafer from the bottom.
3. Results
4. Discussion
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
Abbreviations
| MEMS | Micro-electro-mechanical systems |
| SOI | Silicon-on-insulator |
| FOS | Fiber optic sensors |
| FBG | Fiber Bragg grating |
| DRIE | Deep reactive ion etching |
| BOX | Buried oxide |
| KOH | Potassium hydroxide |
| BOE | Buffered oxide etch |
References
- Sun, H.; He, N.; Application and Research of Microseismic Monitoring System and Hydraulic Fracturing Technology in Coal Mines. Water 2024, 16, 1062. [CrossRef]
- Hu, J.; Fu, M.; Yu, Y.; Li, M. New Method for Monitoring and Early Warning of Fracturing Construction. Processes; 2024, 12, 765. [CrossRef]
- Li, R.; Zhai, H.; Jiang C.; Zhu, W.; Li, X.; Wang, Z.; Wang, Y. A review of laboratory hydraulic fracturing experiments on shales. Geoenergy Sci. Eng.; 2025, 254, 214028. [CrossRef]
- Patel, M.S.; Sinha, B.K. A Dual-Mode Thickness-Shear Quartz Pressure Sensor for High Pressure Applications. IEEE Sens. J.; 2018, 18, 4893-4901. [CrossRef]
- Pendão, C.; Silva, I. Optical Fiber Sensors and Sensing Networks: Overview of the Main Principles and Applications. Sensors; 2022, 22, 7554. [CrossRef]
- Johny, J.; Amos, S.; Prabhu, R. Optical Fibre-Based Sensors for Oil and Gas Applications. Sensors; 2021, 21, 6047. [CrossRef]
- Tosi, D.; Molardi, C.; Sypabekova, M.; Blanc, W. Enhanced Backscattering Optical Fiber Distributed Sensors: Tutorial and Review. IEEE Sens. J.; 2021, 21, 12667–12678. [CrossRef]
- Zhao, N.; Zhang, Z.; Lin, Q.; Yao, K.; Zhu, L.; Chen, Y.; Zhao, L.; Tian, B.; Yang, P.; Jiang, Z. Research on the High Temperature and High Pressure Gold-Plated Fiber Grating Dual-Parameter Sensing Measurement System. Micromachines; 2022, 13, 195. [CrossRef]
- Verma, G.; Mondal, K.; Gupta, A. Si-based MEMS resonant sensor: A review from microfabrication perspective. Microelectron. J.; 2021, 118, 105210. [CrossRef]
- Morten, B.; De Cicco, G.; Prudenziati, M. Resonant pressure sensor based on piezoelectric properties of ferroelectric thick films. Sens. Actuators A: Phys.; 1992, 31, 153-158. [CrossRef]
- Miller, J.M.L.; Ansari, A.; Heinz, D.B.; Chen, Y.; Flader, I.B.; Shin, D.D.; Villanueva, L.G.; Kenny, T.W. Effective quality factor tuning mechanisms in micromechanical resonators. Appl. Phys. Rev.; 2018, 5, 041307. [CrossRef]
- Yao, Z.; Liang, T.; Jia, P.; Hong, Y.; Qi, L.; Lei, C.; Zhang, B.; Xiong, J. A High-Temperature Piezoresistive Pressure Sensor with an Integrated Signal-Conditioning Circuit. Sensors; 2016, 16, 913. [CrossRef]
- Avnet Abacus Pressure Sensors: The Design Engineer’s Guide Available online: https://www.avnet.com/wps/portal/abacus/ solutions/technologies/sensors/pressure-sensors (accessed on 12 June 2025).
- Arefin, M.S.; Redouté, J.M.; Yuce, M.R. A Low-Power and Wide-Range MEMS Capacitive Sensors Interface IC Using Pulse-Width Modulation for Biomedical Applications. IEEE Sens. J.; 2016, 16, 6745-6754. [CrossRef]
- Zhang, C.; Gallichan, R.; Budgett, D.M.; McCormick, D. A Capacitive Pressure Sensor Interface IC with Wireless Power and Data Transfer. Micromachines; 2020, 11, 897. [CrossRef]
- Abdul, B. Development of a Novel Silicon Membrane MEMS Capacitive Pressure Sensor for Biological Applications. Eng. Proc.; 2023, 48, 54. [CrossRef]
- Seo, Y.; Kim, D.; Hall, N.A. Piezoelectric Pressure Sensors for Hypersonic Flow Measurements. JJ. Microelectromech. Syst.; 2019, 28, 271-278. [CrossRef]
- Kordrostami, Z.; Hassanli, K.; Akbarian, A. MEMS piezoresistive pressure sensor with patterned thinning of diaphragm. Microelectron. Int.; 2020, 37, 147-153. [CrossRef]
- Song, P.; Ma, Z.; Ma, J.; Yang, L.; Wei, J.; Zhao, Y.; Zhang, M.; Yang, F.; Wang, X. Recent Progress of Miniature MEMS Pressure Sensors. Micromachines; 2020, 11, 56. [CrossRef]
- Wei, H.; Wang, H.; Xia, Y.; Cui, D.; Shi, Y.; Dong, M.; Liu, C.; Ding, T.; Zhang, J.X.; Ma, Y.; Wang, N.; Wang, Z.; Sun, Y.; Wei, R.; Guo, Z. An overview of lead-free piezoelectric materials and devices. J. Mater. Chem. C; 2018, 6, 12446–12467. [CrossRef]
- Mireles, J.Jr.; Estrada, H.; Ambrosio, R.C. Sensors for hydraulic-induced fracturing characterization. In Proceedings of SPIE 8031, Micro- and Nanotechnology Sensors, Systems, and Applications III, Orlando, Florida, United States, 13 May 2011. [CrossRef]
- Niu, Z.; Zhao, Y.; Tian, B. Design optimization of high pressure and high temperature piezoresistive pressure sensor for high sensitivity. Rev. Sci. Instrum.; 2014, 85, 015001. [CrossRef]
- Li, C.; Cordovilla, F.; Jagdheesh, R.; Ocaña, J.L. Design Optimization and Fabrication of a Novel Structural SOI Piezoresistive Pressure Sensor with High Accuracy. Sensors; 2018, 18, 439. [CrossRef]
- Kanekal, D.; Ravichandran, V.; Shukla, P.; Jindal, S.K.; Sahoo, S.P. Finite element and circuit modelling of SiC MEMS multi-turn piezoresistive sensor device for reliable high-pressure sensing in hostile environments. World J. Eng.; 2025, 18, 439. [CrossRef]
- Bao, M. Analysis and Design Principles of MEMS Devices, 1st ed.; Elsevier: Amsterdam, The Netherlands, 2005; isbn 0444516166.
- Ma, H.Y.; Huang, Q.A.; Qin, M.; Lu, T. A micromachined silicon capacitive temperature sensor for wide temperature range applications. J. Micromech. Microeng.; 2010, 20, 055036. [CrossRef]
- Fan, Z.; Li, Z.; Tang, R.; Wu, G.; Yang, S.; Tu, L. Temperature resolution analysis of resonant MEMS temperature sensor based on quality factor optimization. IEEE Sens. J.; 2025, 25, 14902-14910, . [CrossRef]
- Cai, C.; Tan, J.; Hua, D.; Qin, M.; Zhu, N. Piezoresistive temperature sensors fabricated by a surface micromachining CMOS MEMS process. J. Sci. Rep.; 2018, 8, 17065. [CrossRef]
- Algamili, A.S.; Khir, M.H.; Ahmed, A.Y.; Rabih, A.A.; Ba-Hashwan, S.S.; Alabsi, S.S.; Al-Mahdi, O.L.; Isyaku, U.B.; Ahmed, M.G.; Junaid, M. Fabrication and Characterization of the Micro-Heater and Temperature Sensor for PolyMUMPs-Based MEMS Gas Sensor. Micromachines, 2022, 13, 525. [CrossRef]
- Jaeger, R.C. Introduction to Microelectronic Fabrication, 2nd ed.; Prentice Hall: New Jersey, USA, 2002; isbn 978-0201444940.
- Kanda, Y. Piezoresistance effect of silicon. Sens. Actuators A: Phys.; 1991, 28, 83-91. [CrossRef]
- Liu, Y.; Jiang, X.; Yang, H.; Qin, H.; Wang, W. Structural Engineering in Piezoresistive Micropressure Sensors: A Focused Review. Micromachines; 2023, 14, 1507. [CrossRef]
- COMSOL: MEMS Module Available online: https://www.comsol.com/mems-module (accessed on 21 June 2025).
- Skalka, P.; Kotoul, M. Determination of Mechanical and Fracture Properties of Silicon Single Crystal from Indentation Experiments and Finite Element Modelling. Materials; 2021, 14, 6864. [CrossRef]
- Tilli, M.; Motooka, T.; Airaksinen, V.M.; Franssila, S.; Paulasto-Kröckel, M.; Lindroos, V. Handbook of Silicon Based MEMS Materials and Technologies, 2nd ed.; Elsevier: USA, 2015; isbn 978-0323299657.
- Chen, S.; Zhu, M.Q.; Ma, B.H.; Yuan, W.Z. Design and optimization of a micro piezoresistive pressure sensor. In Proceedings of the 2008 3rd IEEE International Conference on Nano/Micro Engineered and Molecular Systems, Sanya, China, 06-09 January 2008; 351-356. [CrossRef]
- Suhling, J.C.; Jaeger, R.C. Silicon piezoresistive stress sensors and their application in electronic packaging. IEEE Sens. J.; 2001, 1, 14-30. [CrossRef]
- Barlian, A.A.; Park, W.T.; Mallon, J.R.; Rastegar, A.J.; Pruitt, B.L. Review: Semiconductor Piezoresistance for Microsystems. Proc. IEEE; 2009, 97, 513-552. [CrossRef]
- Dziuban, J.A. Bonding in Microsystems Technology, 1st ed.; Springer: Amsterdam, The Netherlands, 2006; ISBN 978-1402045783; [CrossRef]
- Kim, H.S.; Blick, R.H.; Kim, D.M.; Eom, C.B. Bonding silicon-on-insulator to glass wafers for integrated bio-electronic circuits. Appl. Phys. Lett.; 2004, 85, 2370–2372. [CrossRef]
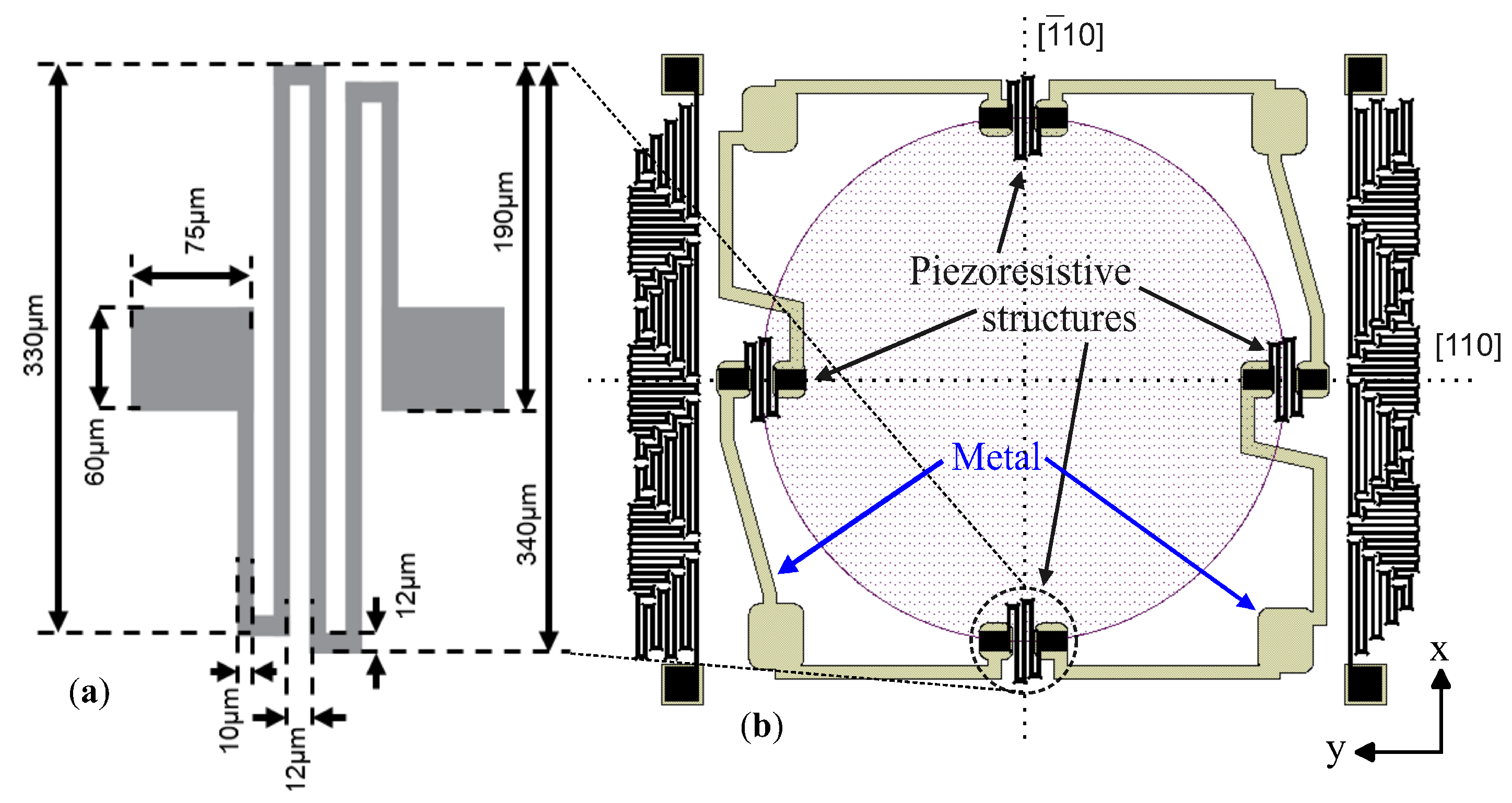
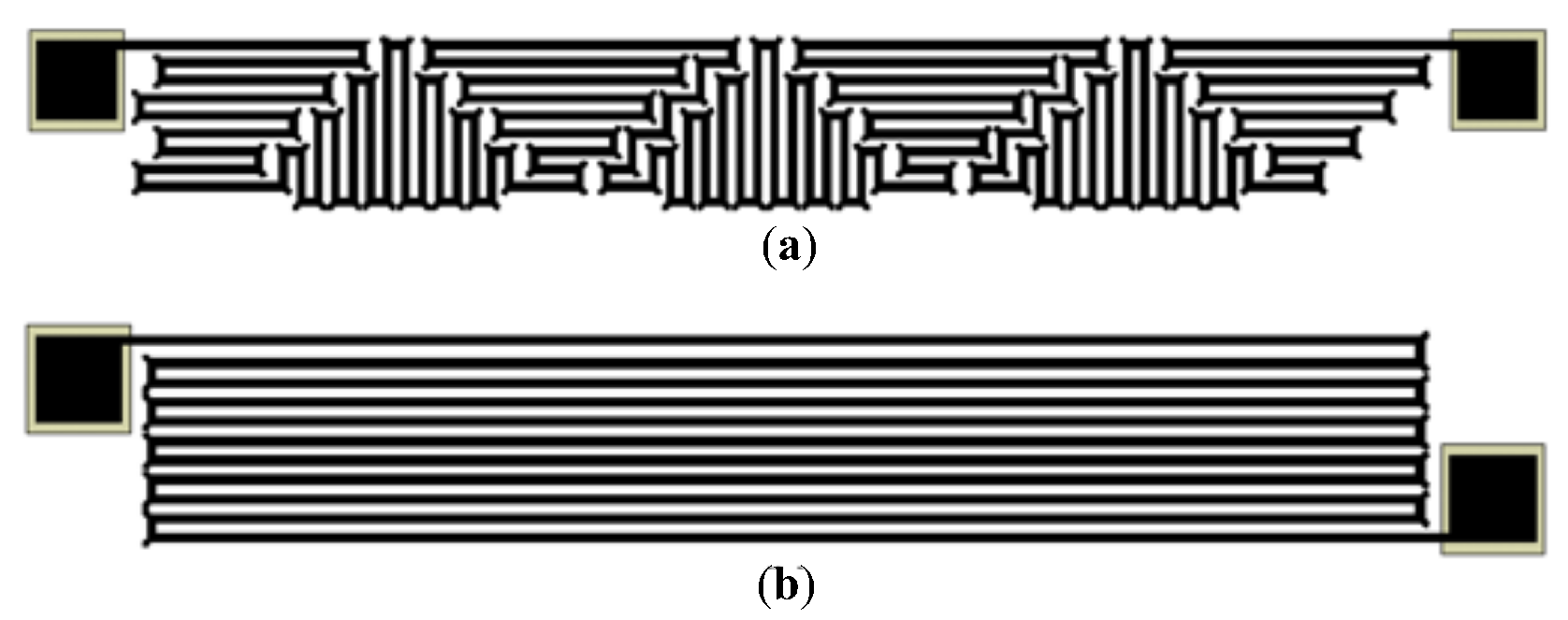
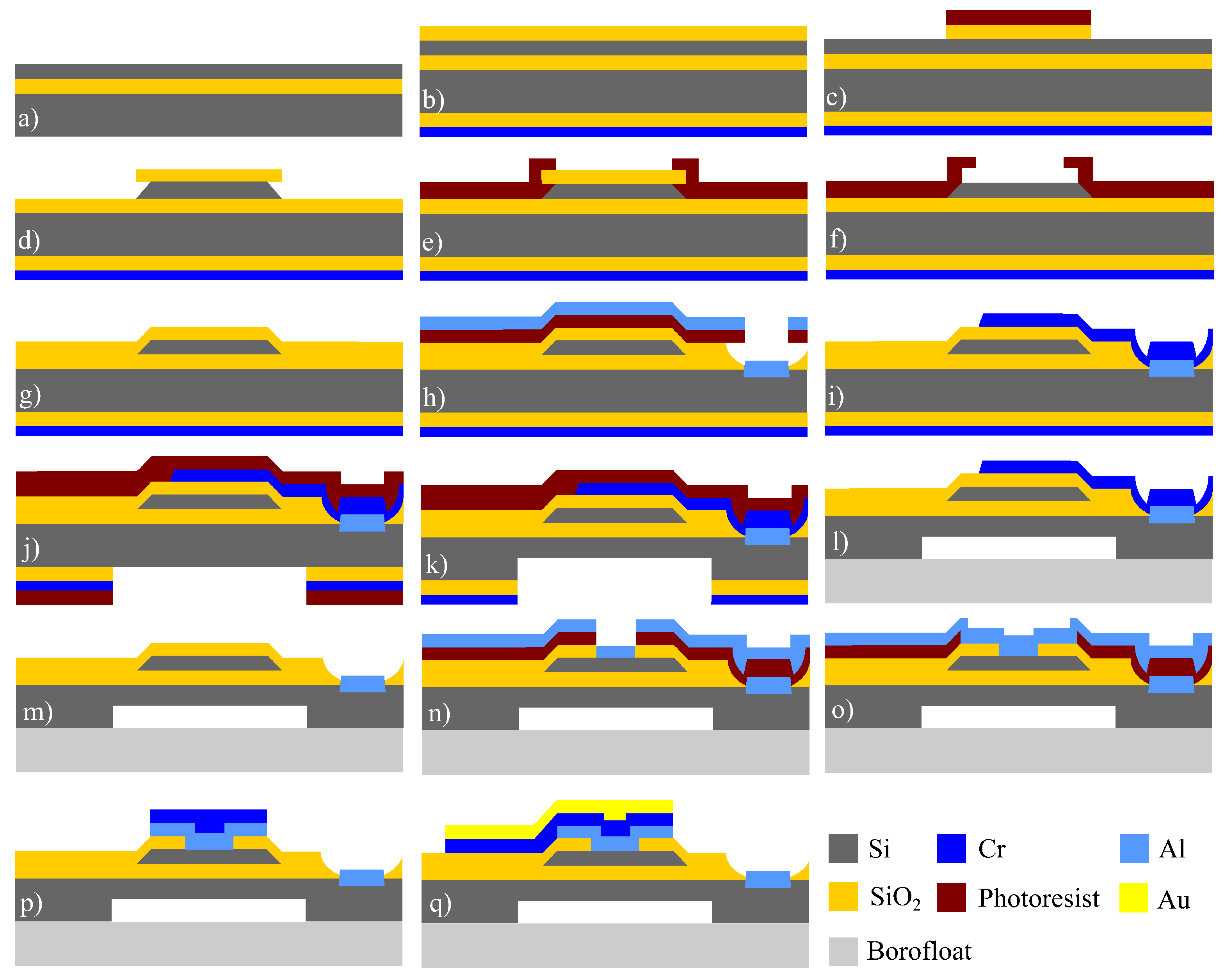
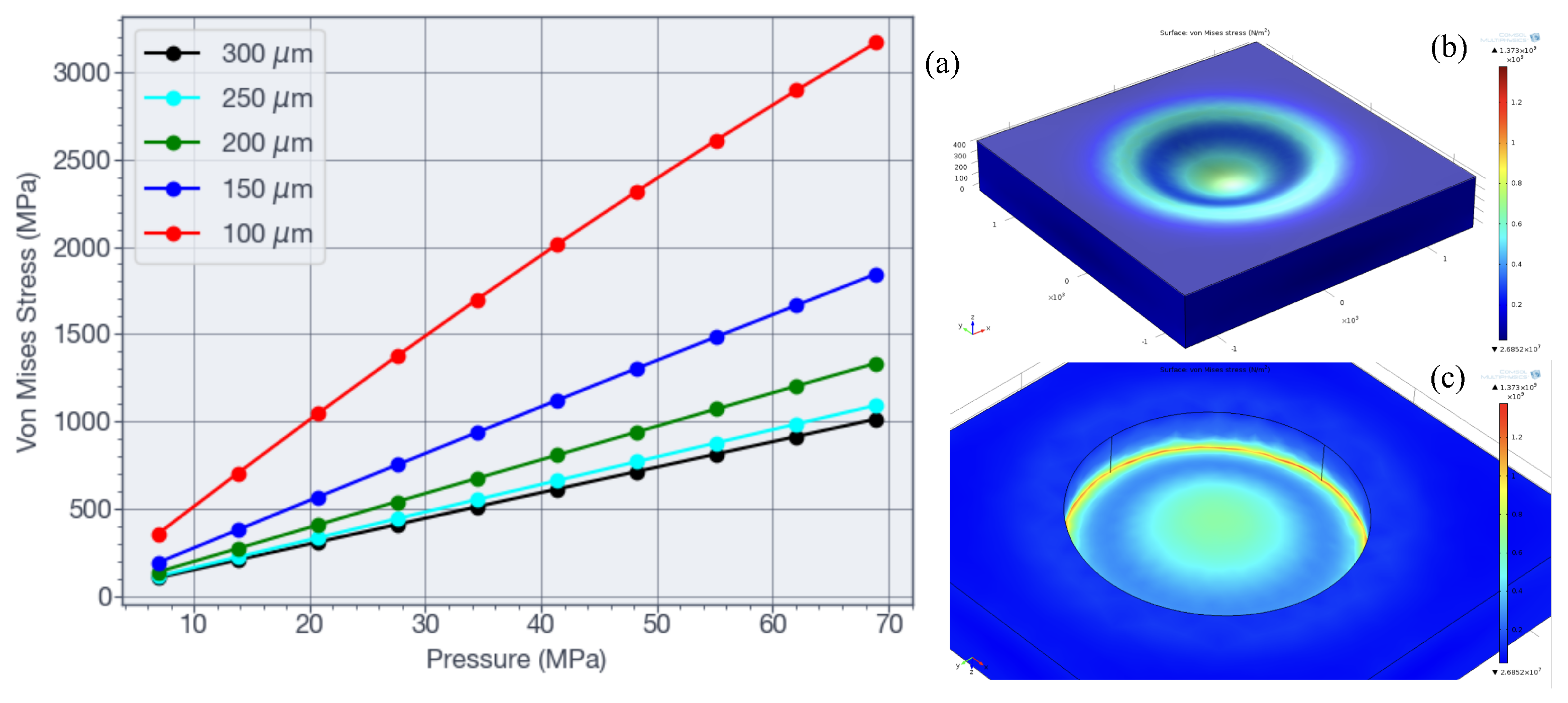
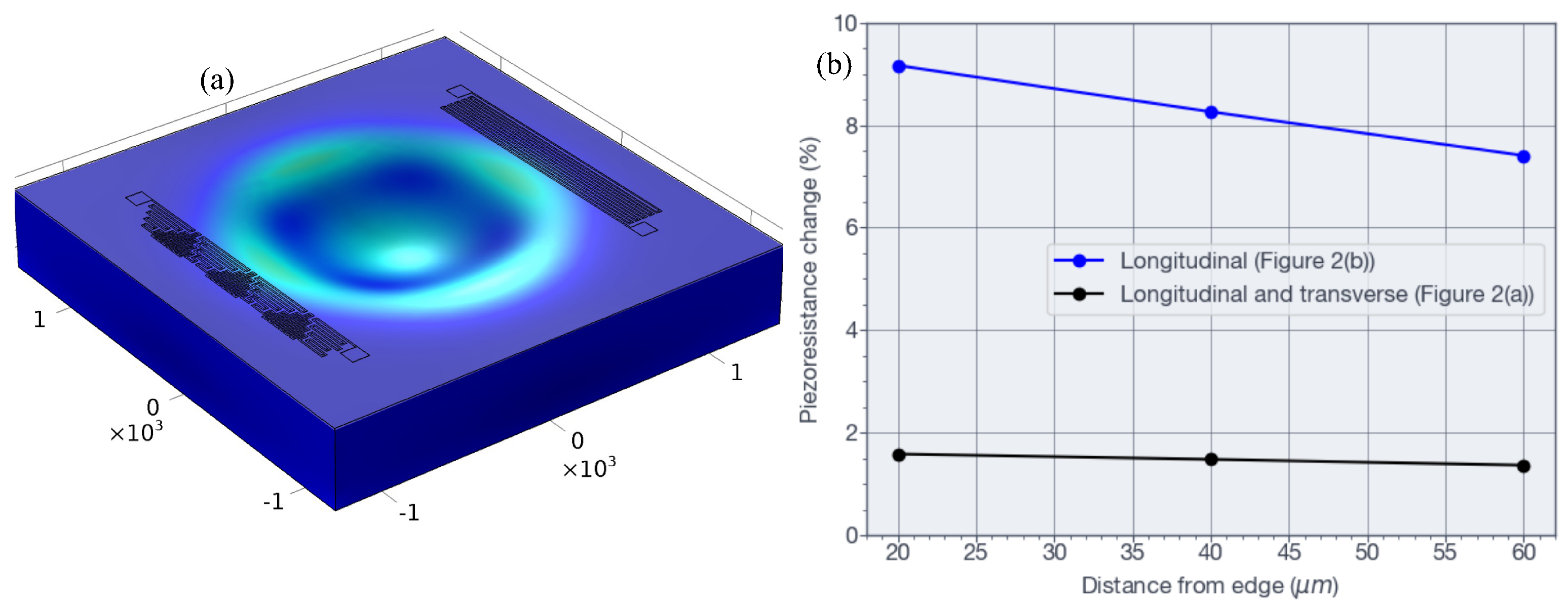
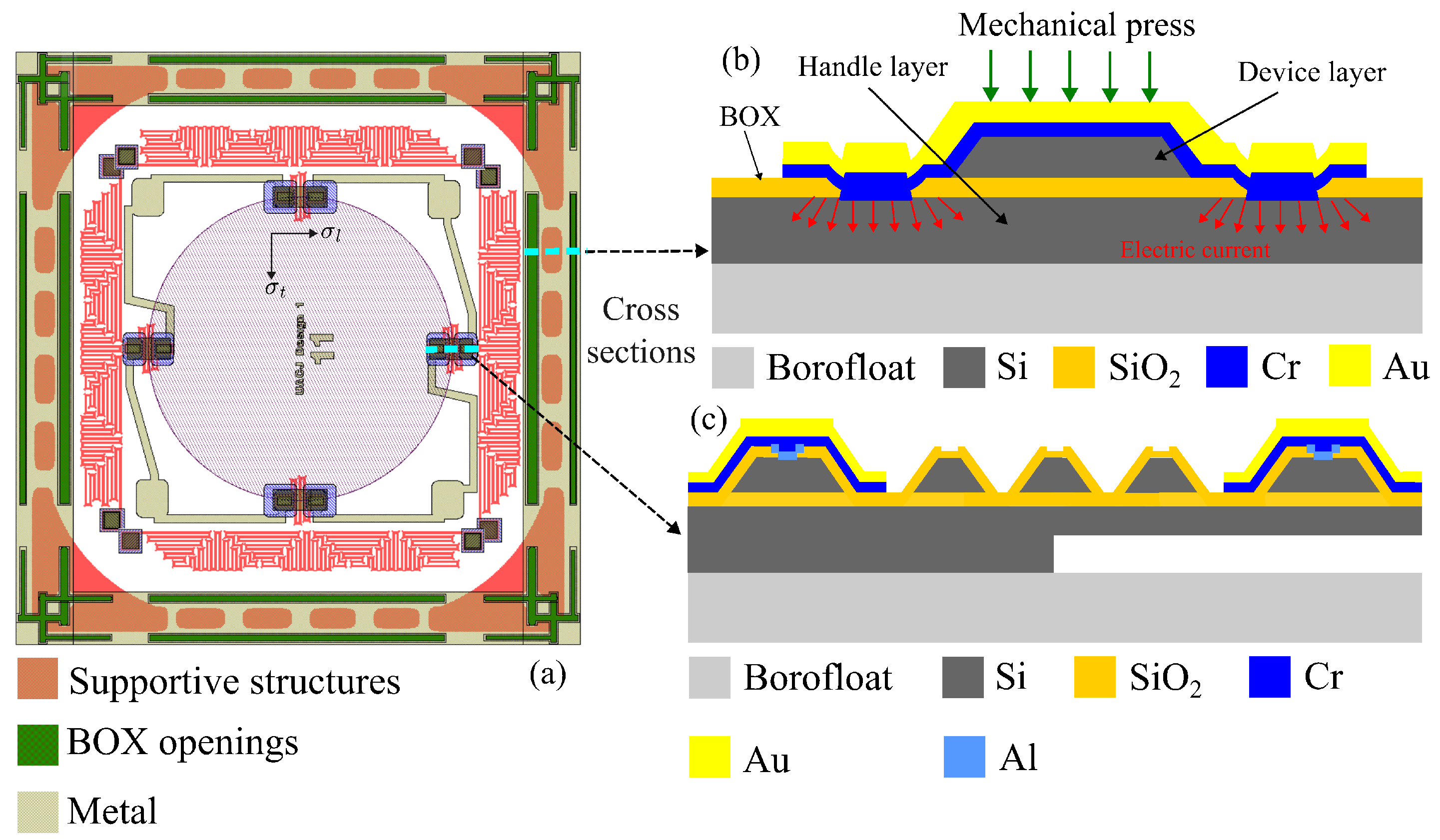
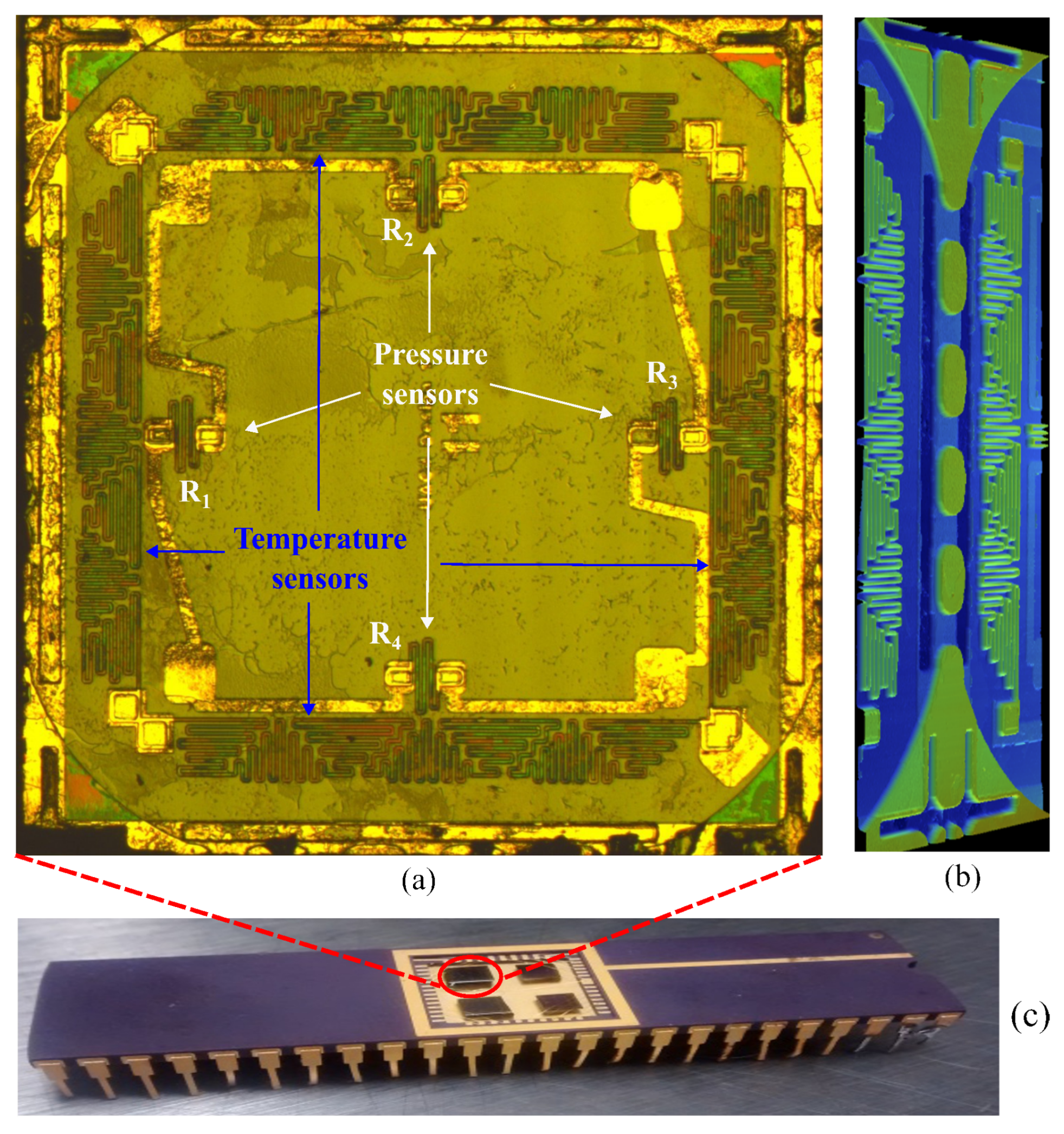
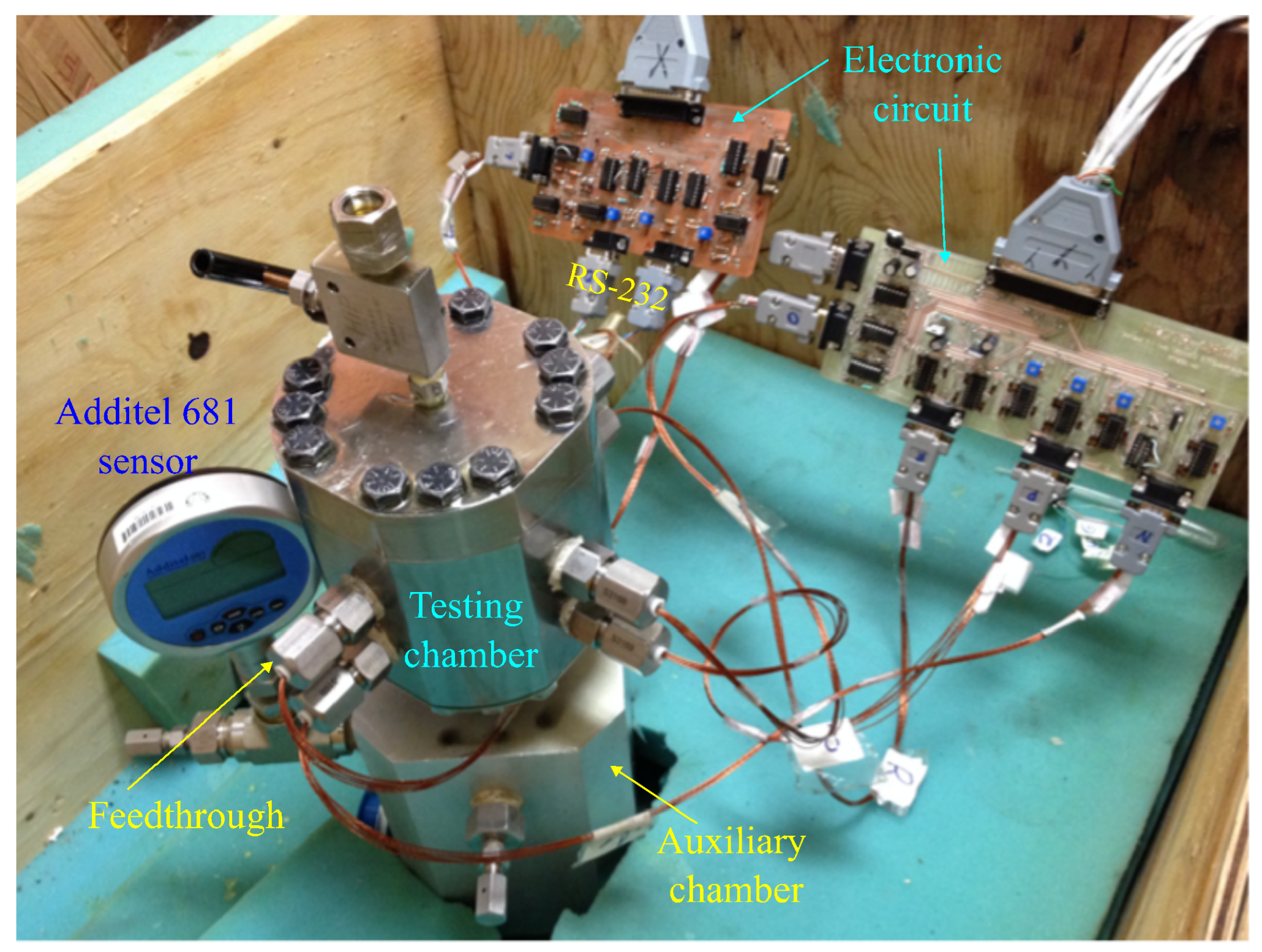


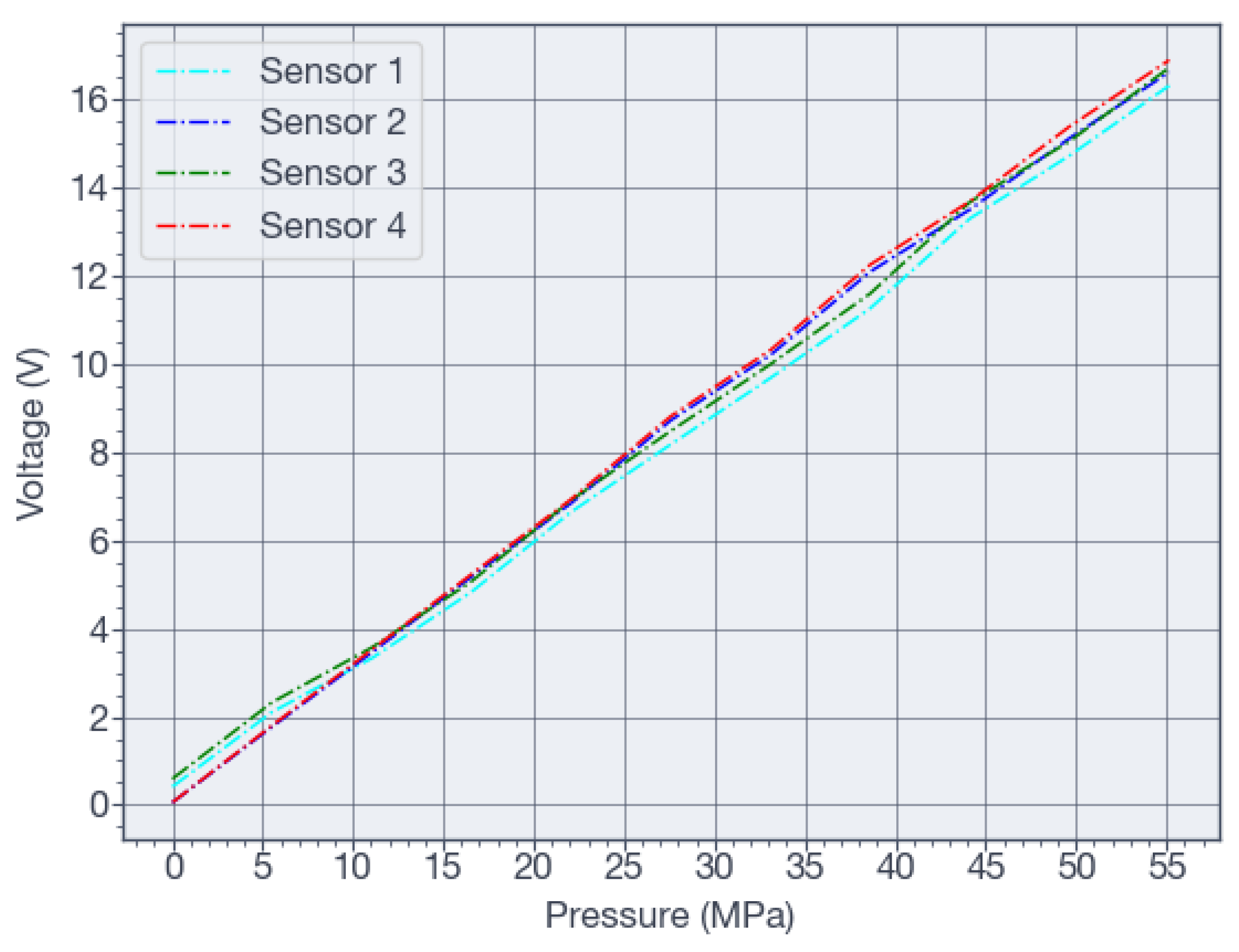
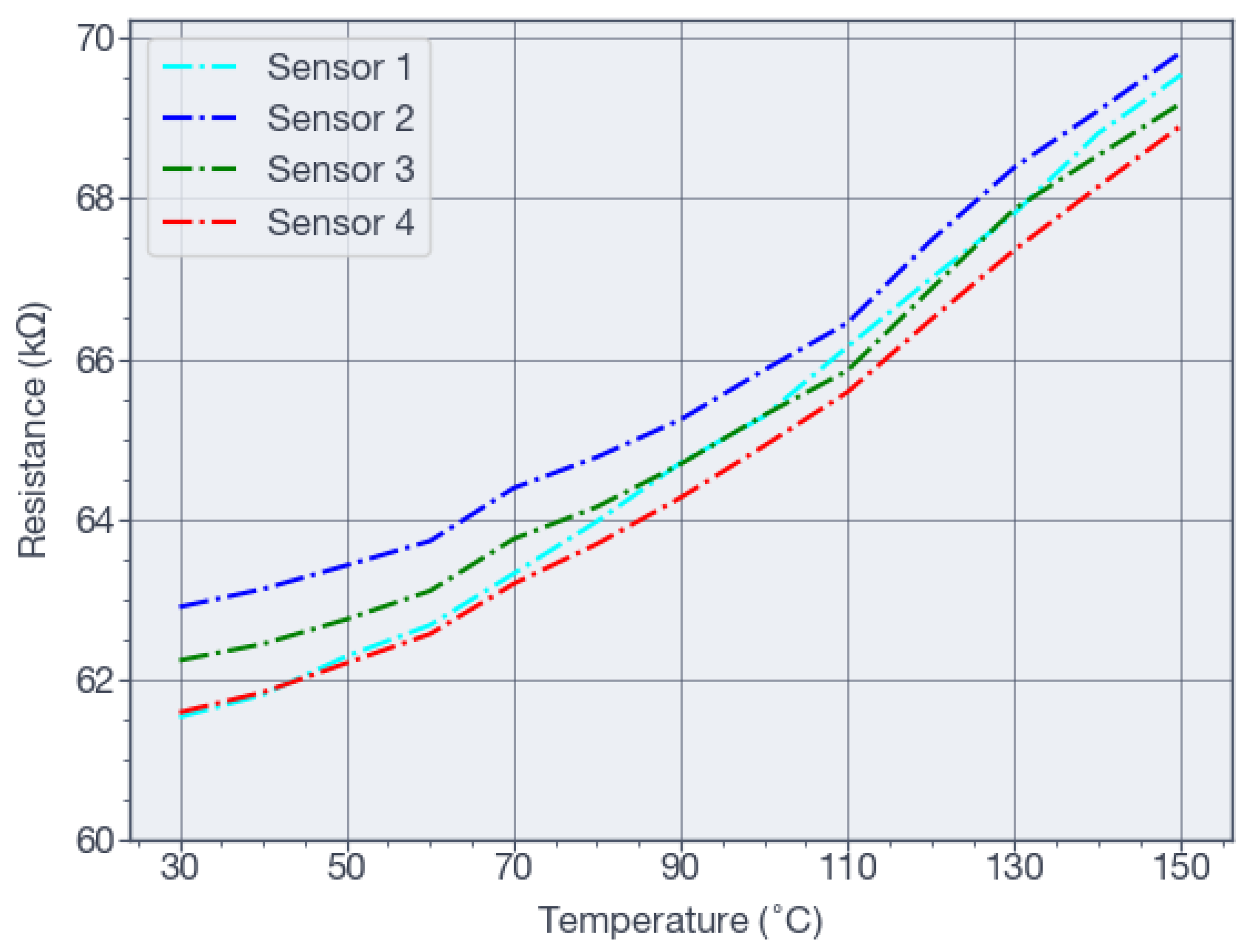
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2026 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).



