Submitted:
27 February 2024
Posted:
28 February 2024
You are already at the latest version
Abstract
Keywords:
1. Introduction
2. Materials and Methods
3. Results
4. Conclusions
Supplementary Materials
Author Contributions
Institutional Review Board Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Y. Mei, W. Huang, W. Di, X. Wang, Z. Zhu, Y. Zhou, F. Huo, W. Wang, Y. Cao, Mechanochemical Lithography, J. Am. Chem. Soc., 2022, 144, 9949-9958.
- G. Tallents, E. Wagenaars, G. Pert, Lithography at EUV wavelengths, Nat. Photonics, 2010, 4, 809-811.
- C. Wagner, N. Harned, Lithography gets extreme, Nat. Photonics, 2010, 4, 24-26.
- J. Fischer, M. Wegener, Three-dimensional optical laser lithography beyond the diffraction limit, Laser Photonics Rev., 2013, 7, 22-44.
- Z. Gan, Y. Cao, R.A. Evans, M. Gu, Three-dimensional deep sub-diffraction optical beam lithography with 9 nm feature size, Nat. Commun., 2013, 4, 1-7.
- J. Shi, A. Ravi, N.E. Richey, H. Gong, S.F. Bent, Molecular Layer Deposition of a Hafnium-Based Hybrid Thin Film as an Electron Beam Resist, ACS Appl. Mater. Interfaces, 2022, 14, 27140-27148.
- X. Wang, P. Tao, Q. Wang, R. Zhao, T. Liu, Y. Hu, Z. Hu, Y. Wang, J. Wang, Y. Tang, H. Xu, X. He, Trends in photoresist materials for extreme ultraviolet lithography: A review, Mater. Today, 2023, 67, 299-319.
- J. Gao, L. Chen, J. Yu, X. Guo, R. Hu, S. Wang, J. Chen, Y. Li, G. Yang, Research Progress on High Resolution Extreme Ultraviolet Photoresist, Chin. J. Appl. Chem., 2021, 38, 1138-1153.
- P. Tao, Q. Wang, M. Vockenhuber, D. Zhu, T. Liu, X. Wang, Z. Hu, Y. Wang, J. Wang, Y. Tang, Y. Ekinci, H. Xu, X. He, Charge Shielding-Oriented Design of Zinc-Based Nanoparticle Liquids for Controlled Nanofabrication, J. Am. Chem. Soc., 2023, 145, 23609-23619.
- S. Hu, J. Chen, T. Yu, Y. Zeng, G. Yang, Y. Li, Chemically Amplified Resist Based on Dendritic Molecular Glass for Electron Beam Lithography, Chem. Res. Chin. Univ., 2023, 39, 139-143.
- M. Guo, X.Y. Liu, T. Li, Q. Duan, X.Z. Dong, J. Liu, F. Jin, M.L. Zheng, Cross-Scale Topography Achieved by MOPL with Positive Photoresist to Regulate the Cell Behavior, Small, 2023, 19, 2303572-2303581.
- J. Sha, J.-K. Lee, S. Kang, V.M. Prabhu, C.L. Soles, P.V. Bonnesen, C.K. Ober, Architectural Effects on Acid Reaction-Diffusion Kinetics in Molecular Glass Photoresists, Chem. Mater., 2010, 22, 3093-3098.
- Q. Wang, H. Cui, X. Wang, Z. Hu, P. Tao, M. Li, J. Wang, Y. Tang, H. Xu, X. He, Exceptional Light Sensitivity by Thiol–Ene Click Lithography, J. Am. Chem. Soc., 2023, 145, 3064-3074.
- Y. Wang, J. Chen, Y. Zeng, T. Yu, S. Wang, X. Guo, R. Hu, P. Tian, M. Vockenhuber, D. Kazazis, Nonchemically Amplified Molecular Resists Based on Sulfonium-Functionalized Sulfone Derivatives for Sub-13 nm Nanolithography, ACS Appl. Nano Mater., 2023, 6, 18480-18490.
- J. Gao, S. Zhang, X. Cui, X. Cong, X. Guo, R. Hu, S. Wang, J. Chen, Y. Li, G. Yang, Effective Optimization Strategy for Electron Beam Lithography of Molecular Glass Negative Photoresist, Adv. Mater. Interfaces, 2023, 2300194.
- B. Cardineau, P. Garczynski, W. Earley, R.L. Brainard, Chain-Scission Polyethers for EUV Lithography, J. Photopolym. Sci. Technol., 2013, 26, 665-671.
- Z. Wang, J. Chen, T. Yu, Y. Zeng, X. Guo, S. Wang, T. Allenet, M. Vockenhuber, Y. Ekinci, G. Yang, Y. Li, Sulfonium-Functionalized Polystyrene-Based Nonchemically Amplified Resists Enabling Sub-13 nm Nanolithography, ACS Appl. Mater. Interfaces, 2022, 15, 2289-2300.
- D.L. Goldfarb, R. Wang, C. Thomas, H. Polgrean, M. Lawson, A. Hess, A. De Silva, R. Gronheid, D.P. Sanders, EUV chemically amplified resist component distribution and efficiency for stochastic defect control, in: Advances in Patterning Materials and Processes XXXVII, 2020.
- K. Arimitsu, M. Yonekura, M. Furutani, Acid-amplifying polymers: synthesis, characterization, and application to environmentally stable chemical amplification positive (ESCAP) resists, RSC Adv., 2015, 5, 80311-80317.
- J. Liu, W. Kang, New Chemically Amplified Positive Photoresist with Phenolic Resin Modified by GMA and BOC Protection, Polymers, 2023, 15, 1598.
- M.S. Ober, D.R. Romer, J. Etienne, P. Thomas, V. Jain, J.F. Cameron, J.W. Thackeray, Backbone degradable poly (aryl acetal) photoresist polymers: synthesis, acid sensitivity, and extreme ultraviolet lithography performance, Macromolecules, 2019, 52, 886-895.
- J.H. Jung, M.J. Kim, K.H. Sohn, H.N. Kang, M.K. Kang, H. Lee, Enhanced Acid Diffusion Control by Using Photoacid Generator Bound Polymer Resist, J. Nanosci. Nanotechnol., 2015, 15, 1764-1766.
- J.Y. Deng, S. Bailey, S.Y. Jiang, C.K. Ober, High-Performance Chain Scissionable Resists for Extreme Ultraviolet Lithography: Discovery of the Photoacid Generator Structure and Mechanism, Chem. Mater., 2022, 34, 6170-6181.
- J. Deng, S. Bailey, S. Jiang, C.K. Ober, Modular Synthesis of Phthalaldehyde Derivatives Enabling Access to Photoacid Generator-Bound Self-Immolative Polymer Resists with Next-Generation Photolithographic Properties, J. Am. Chem. Soc., 2022, 144, 19508-19520.
- H. Xu, K. Sakai, K. Kasahara, V. Kosma, K. Yang, H.C. Herbol, J. Odent, P. Clancy, E.P. Giannelis, C.K. Ober, Metal–Organic Framework-Inspired Metal-Containing Clusters for High-Resolution Patterning, Chem. Mater., 2018, 30, 4124-4133.
- P.J. Evans, C.M. Brick, A. Bell, P. Kandanarachchi, J. Thoresen, L.F. Rhodes, O. Onishi, H. Ikeda, G.M. Benedikt, E. Koronich, Polymers of norbornenyl-4-phenol: Dissolution rate characteristics, positive tone photo-patterning, and polymer properties, J. Appl. Polym. Sci., 2017, 134, 44952-44960.
- Kostko, B. Xu, M. Ahmed, D.S. Slaughter, D.F. Ogletree, K.D. Closser, D.G. Prendergast, P. Naulleau, D.L. Olynick, P.D. Ashby, Y. Liu, W.D. Hinsberg, G.M. Wallraff, Fundamental understanding of chemical processes in extreme ultraviolet resist materials, J. Chem. Phys., 2018, 149, 154305-154314.
- H. Yamamoto, Y. Vesters, J. Jiang, D. De Simone, G. Vandenberghe, T. Kozawa, Role of Metal Sensitizers for Sensitivity Improvement in EUV Chemically Amplified Resist, J. Photopolym. Sci. Technol., 2018, 31, 747-751.
- J. Jing, G. Giordano, R. Fallica, D. DeSimone, G. Vandenberghe, Sensitizer for EUV Chemically Amplified Resist: Metal versus Halogen, J. Photopolym. Sci. Technol., 2019, 32, 15-19.
- H. Li, J. Liu, X. Zheng, C. Ji, Q. Mu, R. Liu, X. Liu, Synthesis of chemically amplified photoresist polymer containing four (Meth) acrylate monomers via RAFT polymerization and its application for KrF lithography, J. Polym. Res., 2016, 23, 1-7.
- L. Wu, M. Baljozovic, G. Portale, D. Kazazis, M. Vockenhuber, T. Jung, Y. Ekinci, S. Castellanos, Mechanistic insights in Zr-and Hf-based molecular hybrid EUV photoresists, J. Micro/Nanolithogr., MEMS, MOEMS, 2019, 18, 013504-013504.
- E.C. Mattson, Y. Cabrera, S.M. Rupich, Y. Wang, K.A. Oyekan, T.J. Mustard, M.D. Halls, H.A. Bechtel, M.C. Martin, Y.J. Chabal, Chemical modification mechanisms in hybrid hafnium oxo-methacrylate nanocluster photoresists for extreme ultraviolet patterning, Chem. Mater., 2018, 30, 6192-6206.
- N. Thakur, R. Bliem, I. Mochi, M. Vockenhuber, Y. Ekinci, S. Castellanos, Mixed-ligand zinc-oxoclusters: efficient chemistry for high resolution nanolithography, J. Mater. Chem. C, 2020, 8, 14499-14506.
- C. Jiang, P. Chen, G. Liu, Cu/photoredox-catalyzed decarboxylative radical C(sp3)-C(sp3) cross-coupling reactions, Sci. China: Chem, 2023, 66, 2858-2862.
- M. Zawadzki, A. Chachereau, J. Kocisek, C.M. Franck, J. Fedor, Electron attachment to hexafluoropropylene oxide (HFPO), J. Chem. Phys., 2018, 149, 204305-204312.
- E. Böhler, J. Warneke, P. Swiderek, Control of chemical reactions and synthesis by low-energy electrons, Chem. Soc. Rev., 2013, 42, 9219-9231.
- Y. Ikari, K. Okamoto, A. Konda, T. Kozawa, T. Tamura, Heating effect of the radiation chemistry of polyhydroxystyrene-type chemically amplified resists, Jpn. J. Appl. Phys., 2020, 59, 086506-086514.
- L. Wang, J. Han, Q. Yuan, W. Cao, X. Zhou, S. Liu, X.-B. Wang, Electron Affinity and Electronic Structure of Hexafluoroacetone (HFA) Revealed by Photodetaching the [HFA]•–Radical Anion, J. Phys. Chem. A, 2020, 125, 746-753.
- Martin, J. Langer, M. Stano, E. Illenberger, Reactions in clusters of acetone and fluorinated acetones triggered by low energy electrons, Int. J. Mass Spectrom., 2009, 280, 107-112.
- C. Szmytkowski, P. Mozejko, E. Ptasinska-Denga, Electron scattering from hexafluoroacetone molecules: cross section measurements and calculations, J. Phys. B: At., Mol. Opt. Phys., 2011, 44, 205202-205.
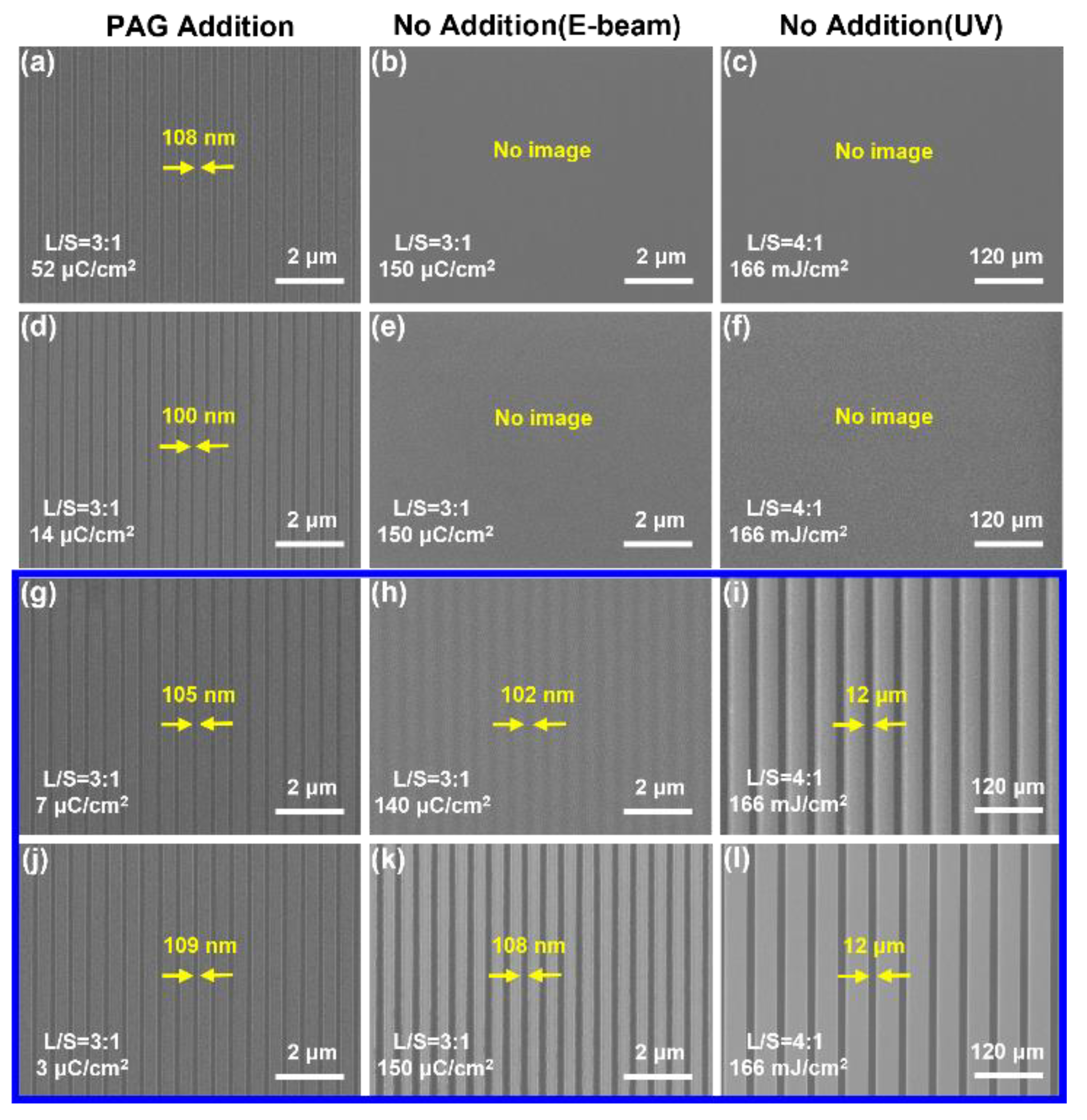
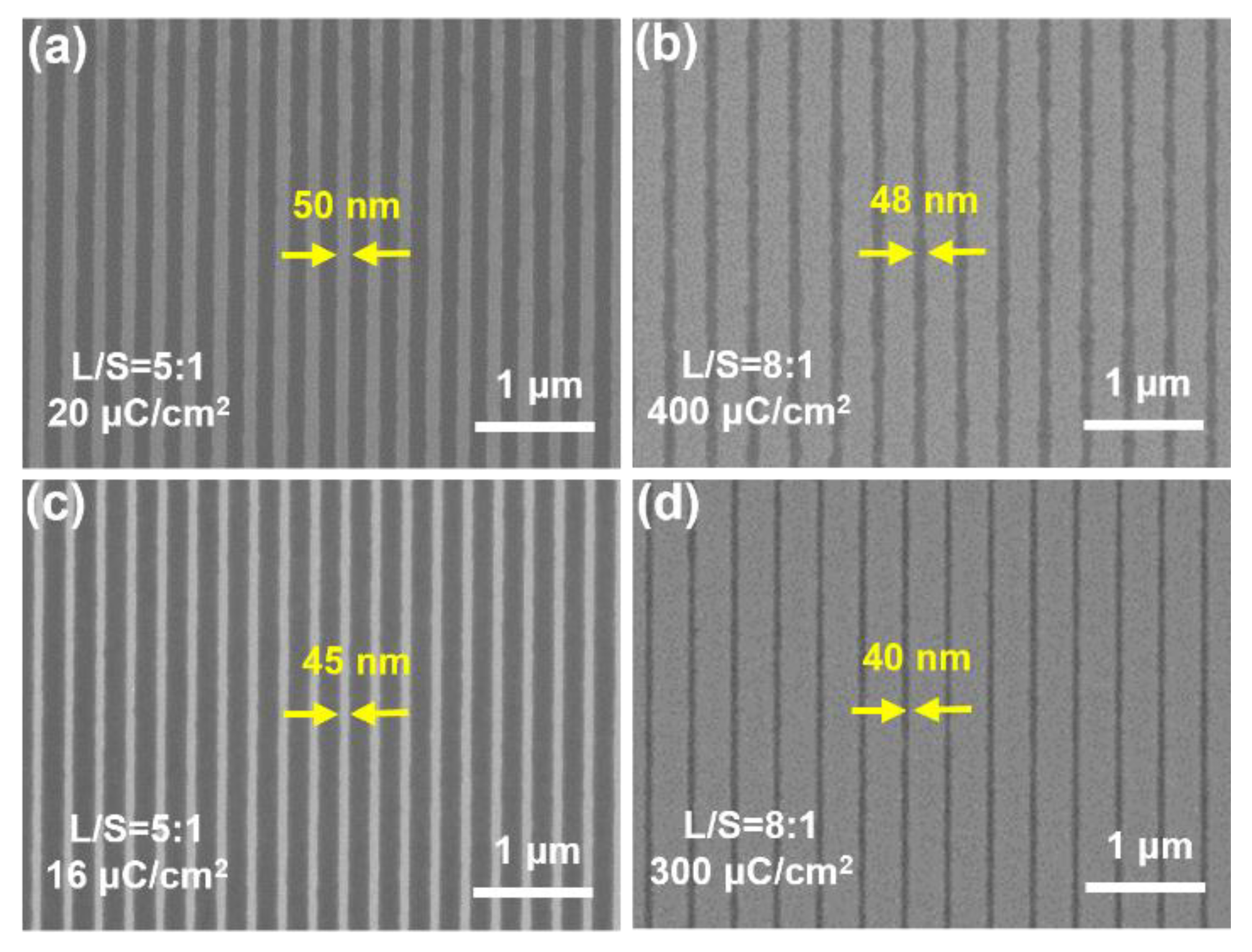



| Sample No. | Polymer | PAGb | Additive | Exposure approacha | |
|---|---|---|---|---|---|
| UV | Electron beam | ||||
| S01 | HF00 | 3 wt.% | - | √ | √ |
| S02 | HF01 | 3 wt.% | - | √ | √ |
| S03 | HF02 | 0.5 wt.% | - | √ | √ |
| S04 | HF03 | 0.5 wt.% | - | √ | √ |
| S05 | HF00 | - | - | × | × |
| S06 | HF01 | - | - | × | × |
| S07 | HF02 | - | - | √ | √ |
| S08 | HF03 | - | - | √ | √ |
| S09 | BJ3015 | - | - | × | × |
| S10 | BJ3015 | - | HF02c | √ | √ |
| S11 | BJ3015 | - | HF03c | √ | √ |
| S12 | BJ3015 | - | M02d | √ | √ |
| S13 | BJ3015 | - | M03d | √ | √ |
| S14 | HF00 | - | M02e | △ | - |
| S15 | HF00 | - | M03e | △ | - |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2024 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).




