Submitted:
09 January 2025
Posted:
10 January 2025
You are already at the latest version
Abstract
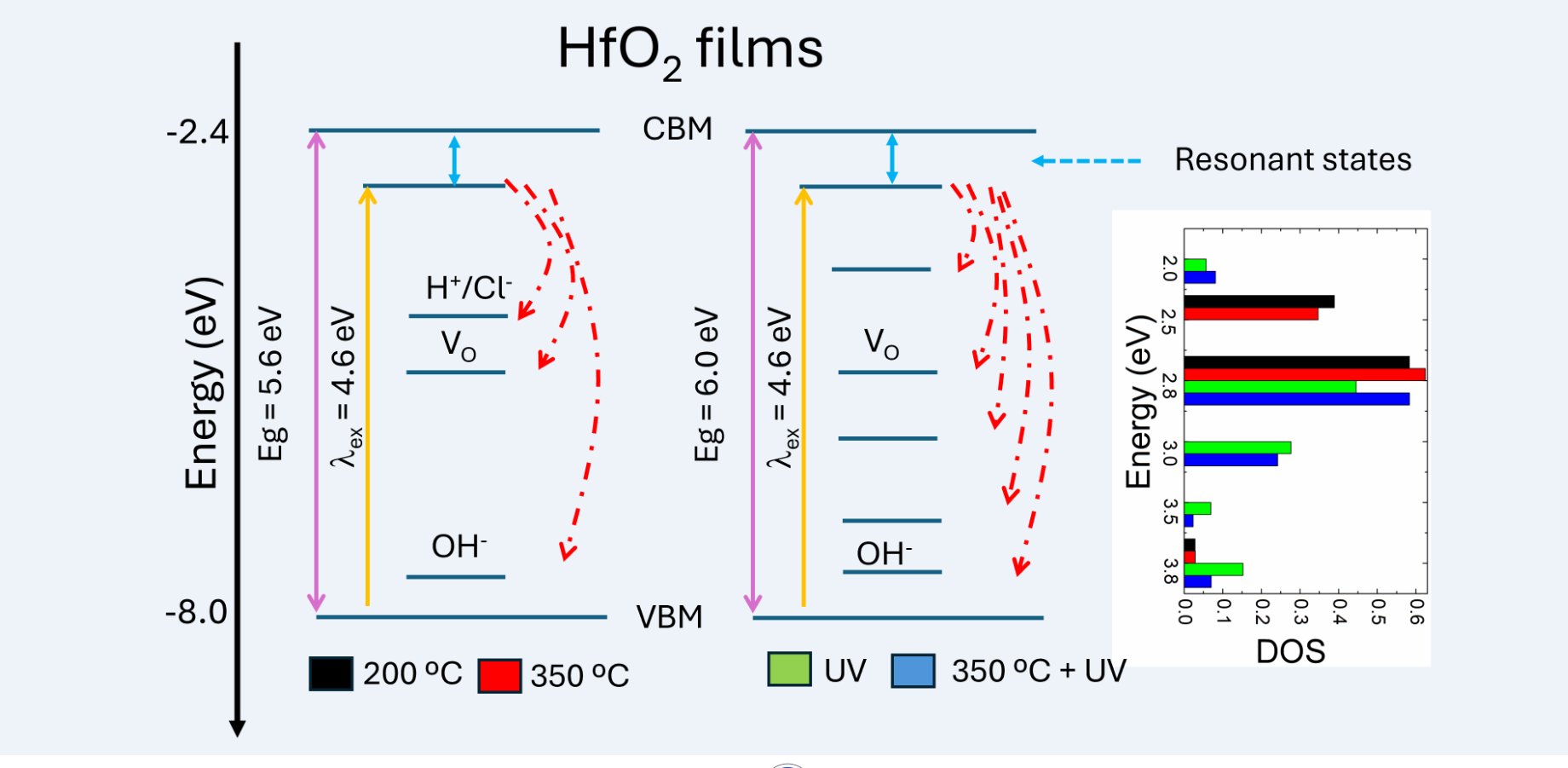
Keywords:
1. Introduction
2. Materials and Methods
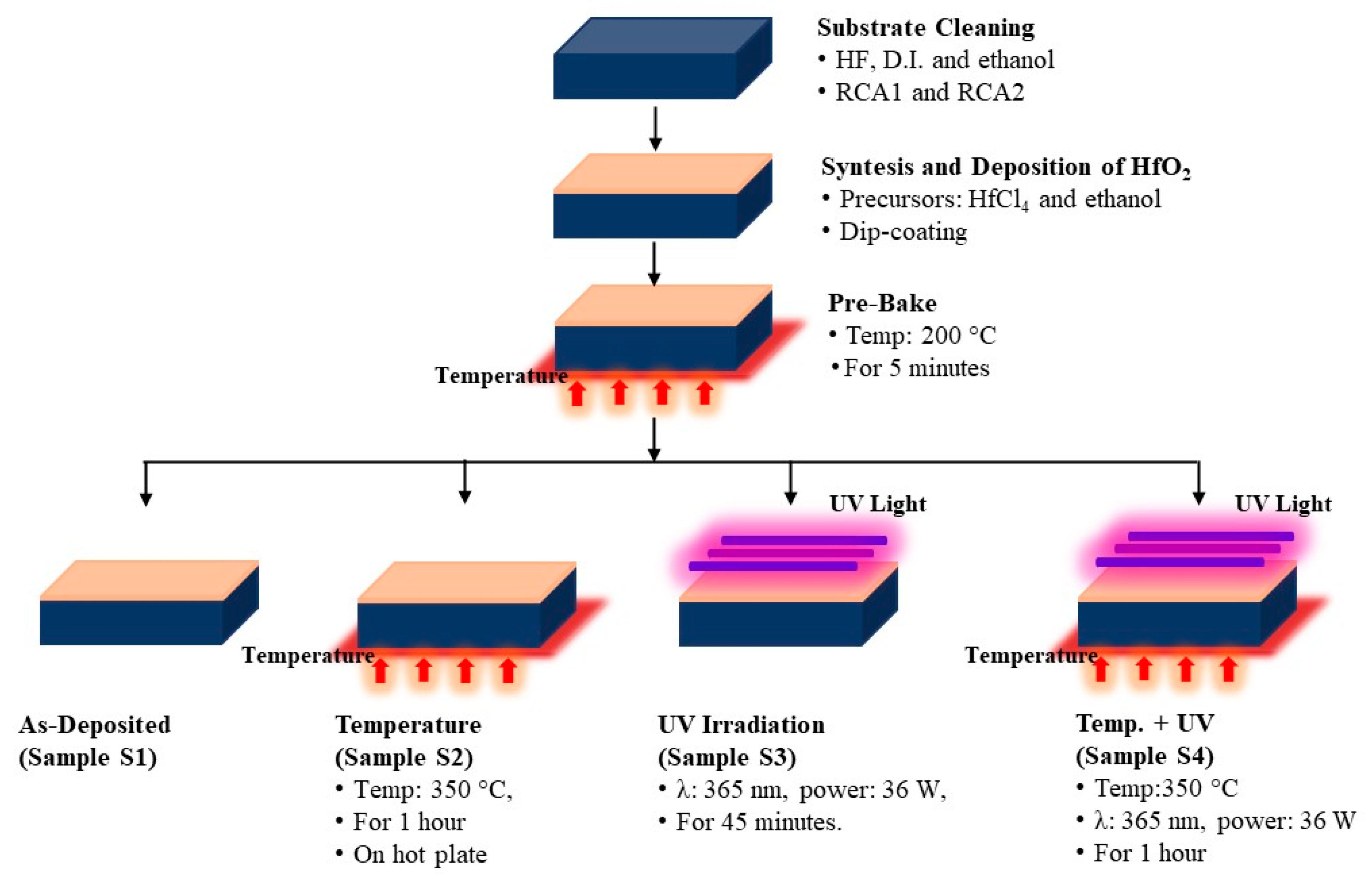
3. Results
3.1. Structural Characterization
3.1.1. X-ray Diffraction
3.1.2. Raman Spectroscopy
3.2. Film Morphology by Atomic Force Microscopy
3.3. Optolectronic Properties
3.3.1. Optical Fluorescence
3.3.2. UV-Vis Spectroscopy
4. Discussion

5. Conclusions
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Seonghwan Hong, Sung Pyo Park, Yeong-gyu Kim, Byung Ha Kang, Jae Won Na & Hyun Jae Kim, Low-temperature fabrication of an HfO2 passivation layer for amorphous indium–gallium–zinc oxide thin film transistors using a solution process, Scientific Reports 7 (2017) 16265. [CrossRef]
- Young Bum Yoo, Jee Ho Park, Kuen Ho Lee, Hyun Woo Lee, Kie Moon Song, Se Jong Leec, and Hong Koo Baik, Solution-processed high-k HfO2 gate dielectric processed under softening temperature of polymer substrates, J. Mater. Chem. C, 2013,1, 1651-1658. [CrossRef]
- Won Kim, Jung-Hwan Bang, Hyun-Seok Uhm, Sang-Hyuk Lee, Jin-Seok Park, Effects of post plasma treatment on material properties and device characteristics in indium zinc oxide thin film transistors, Thin Solid Films 519 (2010) 1573–1577. [CrossRef]
- M. Vargas, N.R. Murphy, C.V. Ramana, Structure and optical properties of nanocrystalline hafnium oxide thin films, Optical Materials, 37 (2014) 621-628. [CrossRef]
- Tingting Tan, Zhengtang Liu, Hongcheng Lu, Wenting Liu, Hao Tian, Structure and optical properties of HfO2 thin films on silicon after rapid thermal annealing, Optical Materials 32, (2010) 432-435. [CrossRef]
- E Rauwel, A Galeckas and P Rauwel, Photoluminescent cubic and monoclinic HfO2 nanoparticles: effects of temperature and ambient, Mater. Res. Express 1 (2014) 1 015035. [CrossRef]
- 2017; 7. Manoj Kumar, Hakyung Jeong, Dongjin Lee, Effect of UV/ozone plasma treatment on sol–gel-derived HfO2 thin films, Ceramics International 43 (2017) 1174–1179, Ceramics International 43 (2017) 1174–1179.
- Luis A. González, Saúl Gálvez-Barboza, Efrain Vento-Lujano, José L. Rodríguez-Galicia, Luis A. García-Cerda, Mn-modified HfO 2 nanoparticles with enhanced photocatalytic activity, Ceramics International 46 (2020) 13466–13473, Ceramics International 46 (2020) 13466–13473.
- Jayaraman, V.; Mahalingam, S.; Chinnathambi, S.; Pandian, G.N.; Prakasarao, A.; Ganesan, S.; Ramasamy, J.; Ayyaru, S.; Ahn, Y.-H. Facile Synthesis of Hafnium Oxide Nanoparticle Decorated on Graphene Nanosheet and Its Photocatalytic Degradation of Organic Pollutants under UV-Light Irradiation. Appl. Sci. 2022, 12, 11222. [CrossRef]
- Arokia Anto Jeffery, Sourabh S. Chougule, Imran Hasan, Jagadeesh Kumar Alagarasan, Parkavi Ravi Sankar, Prathap Somu, Mei-Ching Lin, Keerthika Kumarasamy, Young-Ho Ahn, Jayavel Murugasamy, Oxygen-Vacancy-Rich HfO2–x Nanoparticles Supported on Reduced Graphene Oxide for Electrocatalytic Hydrogen Evolution Reactions, ACS Appl. Nano Mater. 2023, 6, 24, 23053–23063. [CrossRef]
- J. de J. Araiza, L. Álvarez-Fraga, R. Gago, O. Sánchez, Surface morphology and optical properties of hafnium oxide thin films produced by magnetron sputtering, Materials 16 (2023) 5331. [CrossRef]
- Jaemin Kim, Jinsu Park, Duy Phong Pham, Myung Soo Yeo, HwaSung Rhee, Youg-Sang Kim, Eun-Chel Cho, Junsin Yi,Combination of ultraviolet exposure and thermal post-treatment to obtain high quality HfO2 thin films, Ceramics Internationa l47(2021) 9643–9650. [CrossRef]
- Candy Mercado, Zachary Seeley, Amit Bandyopadhyay, Susmita Bose, and Jeanne L. McHale, Photoluminescence of Dense Nanocrystalline Titanium Dioxide Thin Films: Effect of Doping and Thickness and Relation to Gas Sensing, ACS Appl. Mater. Interfaces 2011, 3, 7, 2281–2288. [CrossRef]
- Mingdong Kong, Bincheng Li, Chun Guo, Peng Zeng, Ming Wei and Wenyan He, he Optical Absorption and Photoluminescence Characteristics of Evaporated and IAD HfO2 Thin Films, Coatings 2019, 9, 307;. [CrossRef]
- Jaan Aarik, Hugo Mandar, Marco Kirm, Lembit Pung, Optical characterization of HfO 2 thin films grown by atomic layer deposition. Thin Solid Films 466 (2004) 41 – 47. [CrossRef]
- Papernov, S.; Brunsman, M.D.; Oliver, J.B.; Hoffman, B.N.; Kozlov, A.A.; Demos, S.G.; Shvydky, A.; Cavalcante, F.H.M.; Yang, L.; Demoni, C.S.; et al. Optical properties of oxygen vacancies in HfO2 thin films studied by absorption and luminescence spectroscopy. Opt. Express 2018, 26, 17608–17623. [CrossRef]
- Ibrahim, S. K. J. Al-Ani, Models of optical absorption in amorphous semiconductors at the absorption edge -a revie w and re-evaluation, Czechoslovak Journal of Physics, 44 (1994), 785-797. [CrossRef]
- N. V. Nguyen, Albert V. Davydov, Deane Chandler-Horowitz, and Martin M. Frank, Sub-bandgap defect states in polycrystalline hafnium oxide and their suppression by admixture of silicon, Appl. Phys. Lett. 87, 192903 (2005);. [CrossRef]
- M. C. Cisneros-Morales and C. R. Aita, The effect of nanocrystallite size in monoclinic HfO2 films on lattice expansion and near-edge optical absorption, Applied Physics Letters 96, (2010) 191904. [CrossRef]
- T. V. Perevalov, V. Sh. Aliev, V. A. Gritsenko, A. A. Saraev, V. V. Kaichev, E. V. Ivanova, and M. V. Zamoryanskaya, The origin of 2.7 eV luminescence and 5.2 eV excitation band in hafnium oxide, Applied Physics Letters 104, 071904 (2014);. [CrossRef]
- Zhongrui Wang, HongYu Yu & Haibin Su, The transport properties of oxygen vacancy-related polaron-like bound state in HfO x, Scientific Reports 3 (2013) 3246. [CrossRef]


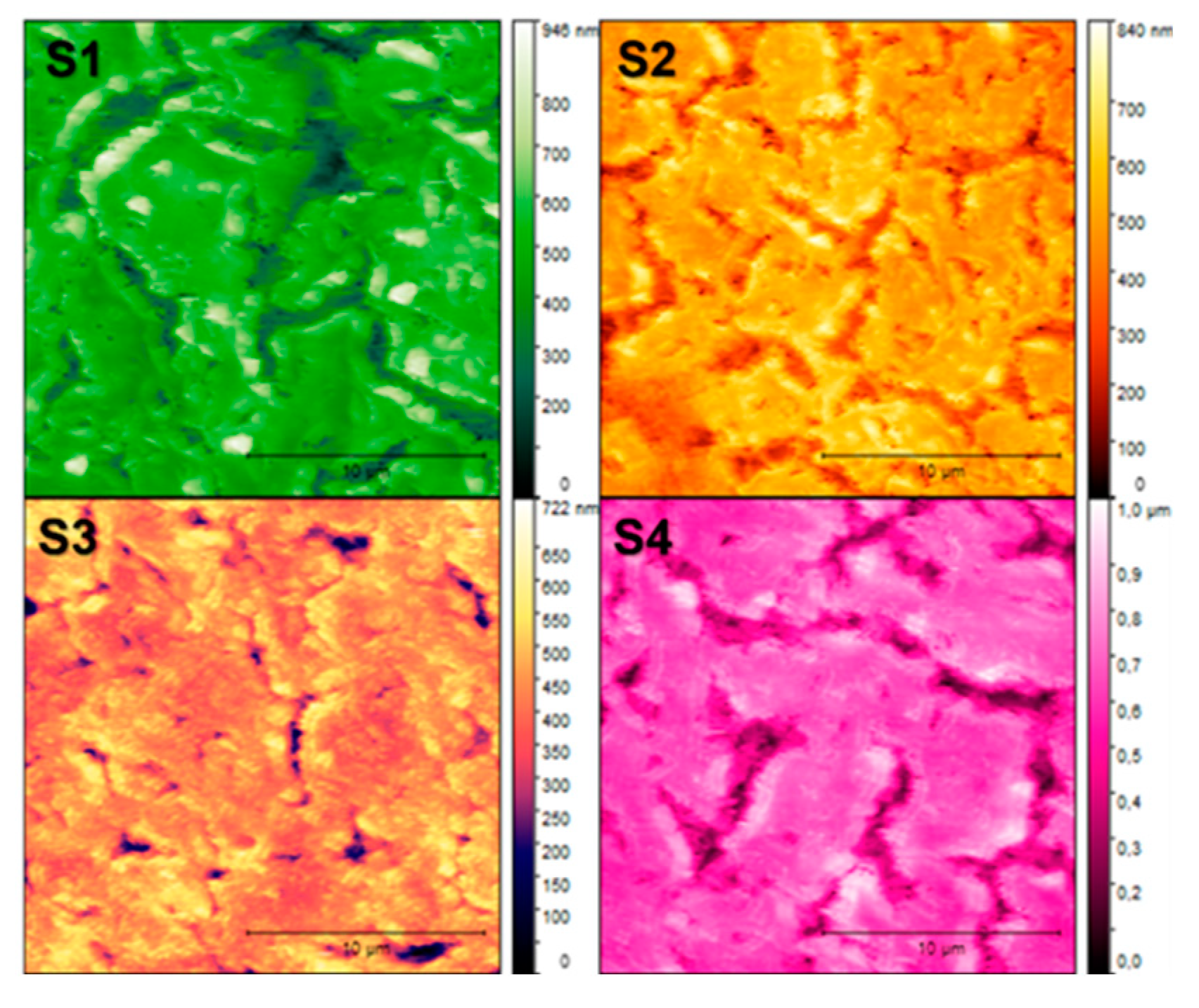
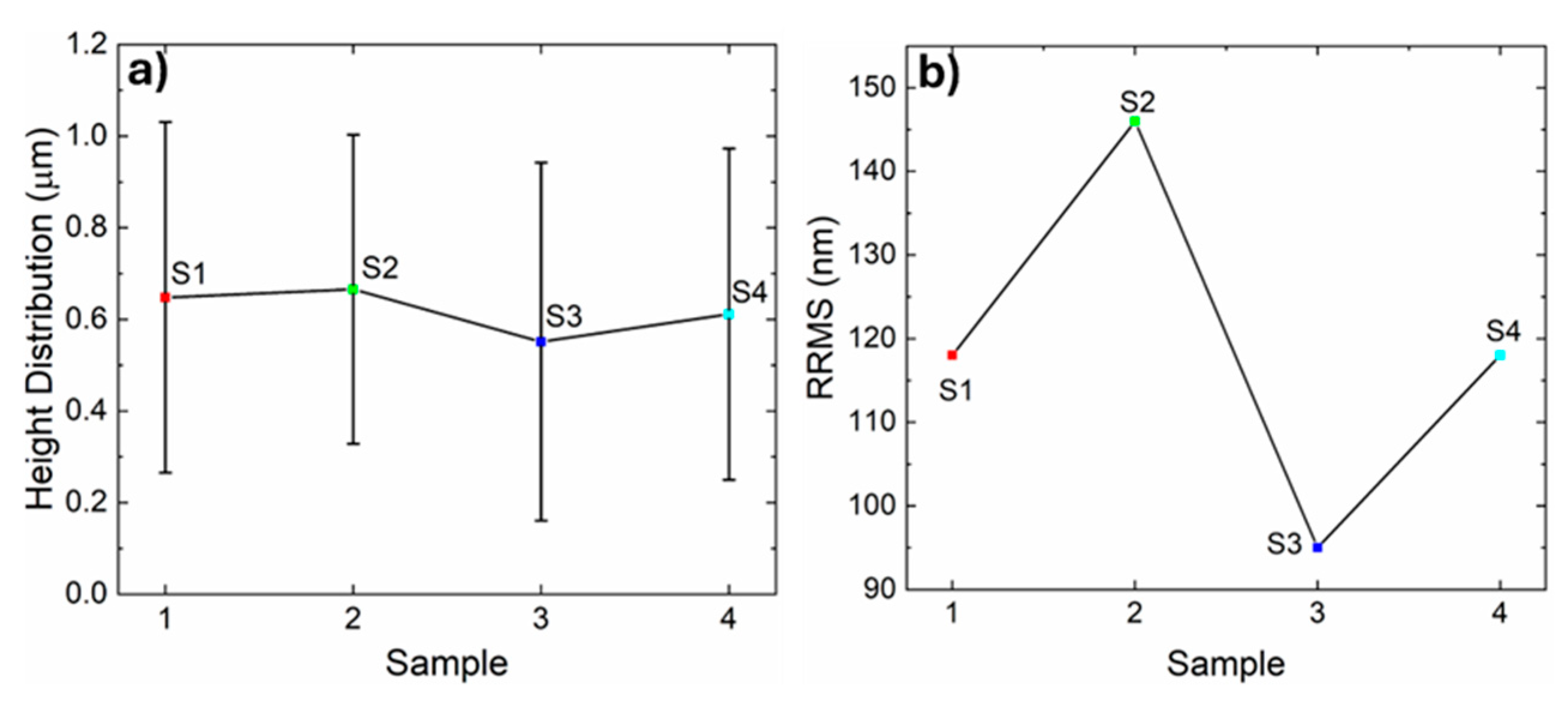

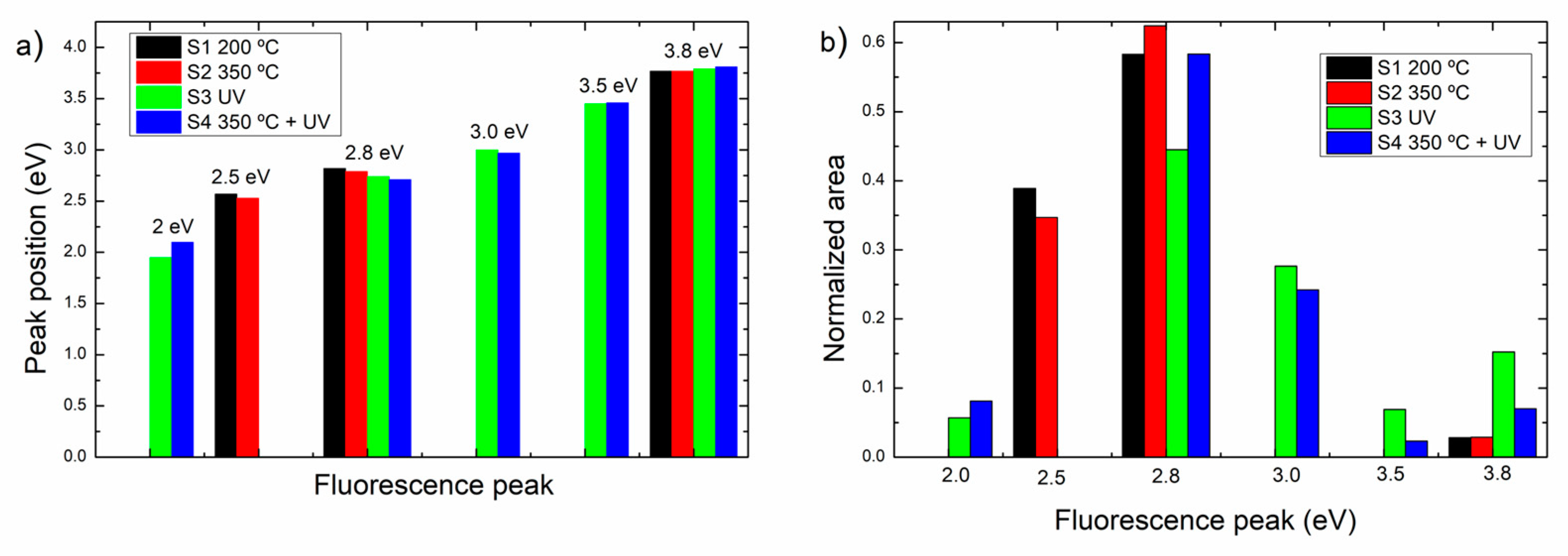
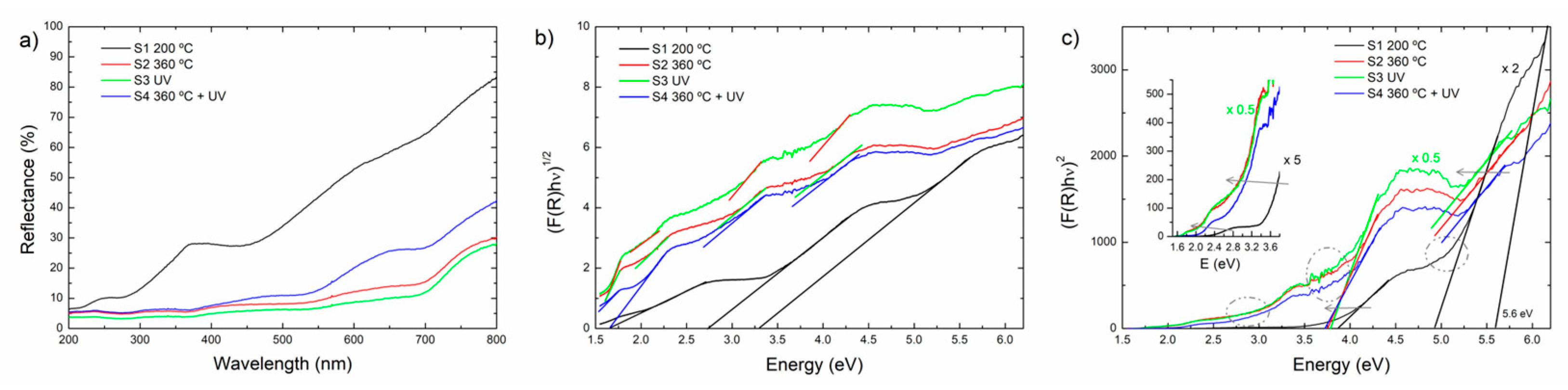
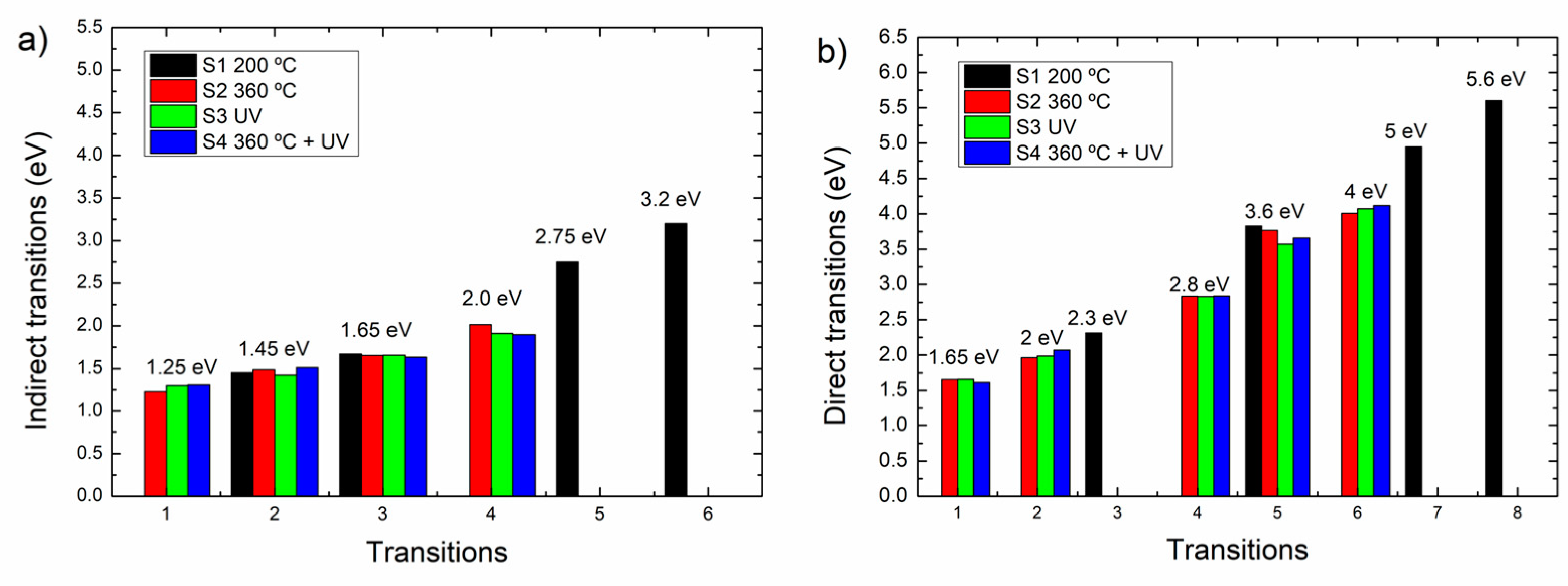
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2025 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).



